1引言
硅片上的有機(jī)﹑無(wú)機(jī)和顆粒狀雜質(zhì)通常是以化學(xué)或物理吸附的方式結(jié)合于硅片表面或包埋于硅片自身的氧化膜中�。這些沾染物及顆粒狀雜質(zhì)會(huì)嚴(yán)重影響器件的性能﹑可靠性和成品率��。實(shí)驗(yàn)表明���,有超過(guò)50%的次品是由于清洗不當(dāng)造成的,
從而使得超凈表面的制備工藝成了制作大規(guī)模和超大規(guī)模(VLSI)集成電路(IC)的關(guān)鍵技術(shù)�����。所謂超凈表面即要求硅片表面無(wú)顆粒狀雜質(zhì)和有機(jī)����、金屬沾染物(保守地說(shuō)��,表面的金屬雜質(zhì)應(yīng)少于每平方厘米1010個(gè)原子�;大于0.1mm的粒子應(yīng)少于每平方厘米0.1個(gè)),無(wú)自身氧化物,完全氫終端﹑表面的微觀粗糙度要小[1�����,2]�。因此清洗時(shí)必須有效地去除表面有機(jī)與無(wú)機(jī)沾染物���,而又不侵蝕和破壞硅片表面或?qū)е卤砻娲植诨?/span>
目前世界各國(guó)在半導(dǎo)體器件生產(chǎn)中普遍采用的是Kern于1970年發(fā)明的RCA標(biāo)準(zhǔn)清洗方法[1]����。自90年代初期,人們開(kāi)始致力于新型清洗工藝和清洗劑的研究以取代RCA清洗技術(shù)����。1996年W.A.Cady和M.Varadarajan[3]提出了采用四甲基氫氧化氨[N(CH3)4OH)]與羧酸鹽緩沖劑配置的堿性水溶液噴霧清洗法��;1997年JoongS.Jeon和SriniRaghavan[4�����,5]提出了利用兆聲波激發(fā)臭氧水對(duì)硅片進(jìn)行清洗����;1998年GeoffreyL.Bakker[6]等人提出了用水和水/CO2混合溶液在高溫��、高壓下的清洗等等���。1995年山東大學(xué)光電材料與器件研究所研制成功了含表面活性劑的新型清洗劑和與之配套的新型DGQ系列清洗工藝��。它有DGQ-1﹑DGQ-2兩種型號(hào)���,DGQ-1去除油脂類雜質(zhì)﹑DGQ-2去除金屬類雜質(zhì),使用時(shí)稀釋19倍�。該清洗技術(shù)的清洗效果與RCA清洗技術(shù)相當(dāng)�,目前已在半導(dǎo)體分離器件得到了應(yīng)用。我們對(duì)它的清洗效果與標(biāo)準(zhǔn)RCA清洗技術(shù)進(jìn)行了比較���,結(jié)果表明含表面活性劑水溶液的新型清洗技術(shù)在去除有機(jī)物和金屬雜質(zhì)離子方面相當(dāng)于標(biāo)準(zhǔn)RCA清洗工藝[7]。其清洗的硅片����,表面平整度高,明顯優(yōu)于標(biāo)準(zhǔn)RCA清洗技術(shù)[8]��,而且新型清洗劑具有無(wú)毒﹑無(wú)腐蝕性﹑對(duì)人體無(wú)危害﹑對(duì)環(huán)境無(wú)污染�,工藝簡(jiǎn)單﹑操作方便等優(yōu)點(diǎn)。HF在清洗中的作用是什么��,下面我們以實(shí)驗(yàn)來(lái)加以說(shuō)明�����。

2實(shí)驗(yàn)結(jié)果和討論
2.1HF稀溶液在DGQ系列清洗工藝中的作用
為了確定HF稀溶液在DGQ系列清洗工藝中的作用,將2英寸的硅圓片分4組分別按照表1中的方法進(jìn)行清洗�����。
按照上述四種方法清洗好的硅片用傅立葉變換紅外吸收光譜儀測(cè)量它們的紅外(透過(guò))吸收狀況并繪制吸收光譜圖,如圖1所示�����。從圖1中可以看出譜線中有兩個(gè)明顯的吸收峰����,在609波數(shù)處的峰是硅襯底吸收峰����,1108波數(shù)處的吸收是不同價(jià)態(tài)硅氧化物的復(fù)合吸收�,其中的尖峰是由+2價(jià)態(tài)硅氧化物吸收產(chǎn)生的���;由曲線3和曲線4可以看出,無(wú)論是常規(guī)的酸堿清洗還是DGQ系列清洗劑的清洗��,在沒(méi)有HF稀溶液浸泡的情況下�����,1108波數(shù)處的吸收都是不同價(jià)態(tài)硅氧化物的復(fù)合吸收��,表明清洗后的硅片表面依然有一層不同價(jià)態(tài)硅氧化物存在;由曲線1和曲線2可以看出����,用HF稀溶液浸泡后清洗的硅片��,復(fù)合吸收變成僅有二氧化硅的吸收;表明DGQ-1﹑DGQ-2清洗劑與SC-1﹑SC-2一樣對(duì)硅片表面的硅氧化膜都沒(méi)有去除作用�。因此采用DGQ系列清洗劑清洗硅片時(shí)���,首先需用HF稀溶液浸泡硅片,將硅片表面的自然氧化膜去掉�,以利于包埋于氧化層內(nèi)的金屬和有機(jī)污染物的去除����。
Ishizaka證明了標(biāo)準(zhǔn)RCA清洗工藝在對(duì)半導(dǎo)體表面清洗的同時(shí),在硅片的表面生成了一層厚度1~1.5nm的二氧化硅鈍化膜[9]���。比較用標(biāo)準(zhǔn)RCA清洗工藝和用DGQ系列清洗工藝清洗的硅片的紅外透過(guò)吸收譜���,二者除了硅襯底的吸收外���,也都有二氧化硅的吸收�,而且吸收峰的高度基本相同����。這表明用DGQ系列清洗工藝清洗硅片同樣在硅片表面生成了一層厚度1~1.5nm的二氧化硅鈍化膜。
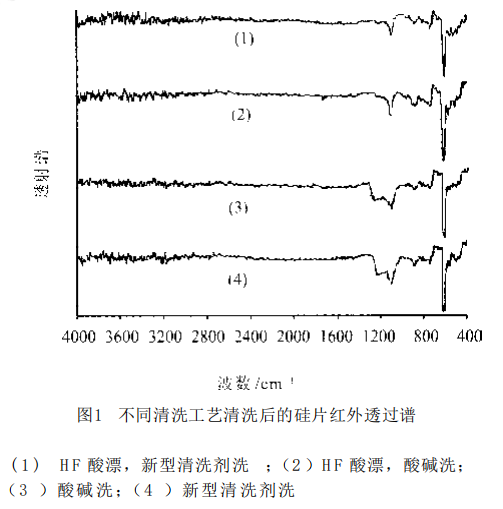
2.2清洗后硅片表面的潤(rùn)濕性能
硅片經(jīng)不同的清洗工藝清洗后其表面的潤(rùn)濕性能各不相同�����。為了測(cè)定硅片表面的潤(rùn)濕性能,實(shí)驗(yàn)中采用了XZD-3型全量程界面張力﹑接觸角測(cè)試儀���,它是利用旋轉(zhuǎn)滴法測(cè)量接觸角而確定硅片表面潤(rùn)濕性的。接觸角示意如圖2���,根據(jù)角度的大小即可判定硅片的潤(rùn)濕狀況���。

表2給出了硅片經(jīng)常規(guī)酸堿清洗﹑DGQ系列新型清洗劑清洗和僅用稀HF浸泡20秒后高純水沖洗的硅片表面的接觸角���。

由圖2我們知道,角度越小����,表明高純水從硅片表面排開(kāi)氣泡的能力越強(qiáng)����,高純水與硅片的接觸面積也就越大���,硅片表面的潤(rùn)濕性也就越好�����。從表2中可以看到DGQ系列新型清洗劑清洗后的硅片表面的接觸角的平均值最?。?.8°)�����,因而潤(rùn)濕性也就最好。
3結(jié)論
紅外吸收譜測(cè)量的結(jié)果表明:無(wú)論是常規(guī)的酸堿清洗還是DGQ系列清洗劑的清洗���,在沒(méi)有HF稀溶液浸泡的情況下,1108波數(shù)處的吸收都是不同價(jià)態(tài)硅氧化物的復(fù)合吸收�,用HF稀溶液浸泡后清洗的硅片,復(fù)合吸收變成僅有二氧化硅的吸收�。因此�����,無(wú)論是用標(biāo)準(zhǔn)RCA清洗工藝�,還是采用DGQ系列清洗劑清洗硅片時(shí),首先需用HF稀溶液浸泡硅片��,將硅片表面的自然氧化膜去掉���,以利于包埋于氧化層內(nèi)的金屬和有機(jī)污染物的去除。
采用XZD-3型全量程界面張力﹑接觸角測(cè)試儀測(cè)量接觸角表明����,DGQ系列新型清洗劑清洗后的硅片表面的接觸角為最小����,因而潤(rùn)濕性也最好��;標(biāo)準(zhǔn)RCA清洗劑清洗的硅片表面的接觸角稍大一點(diǎn)�����,潤(rùn)濕性稍差一些��;而僅用HF稀溶液浸泡20秒后高純水沖洗的硅片接觸角為最大�,因而潤(rùn)濕性最差����。