1.1寬禁帶半導(dǎo)體的概念和發(fā)展
寬禁帶半導(dǎo)體(WBS)是自第一代元素半導(dǎo)體材料(Si)和第二代化合物半導(dǎo)體材料(GaAs、GaP、InP等)之后發(fā)展起來(lái)的第三代半導(dǎo)體材料���。這類材料主要包括SiC(碳化硅)、C-BN(立方氮化硼)���、GaN(氮化鎵、)AlN(氮化鋁)、ZnSe(硒化鋅)以及金剛石等���。
第二代半導(dǎo)體GaAs與Si相比除了禁帶寬度增大外�����,其電子遷移率與電子飽和速度分別是Si的6倍和2倍�,因此其器件更適合高頻工作��。GaAs場(chǎng)效應(yīng)管器件還具有噪聲低�����、效率高和線性度好的特點(diǎn)但相比第三代半導(dǎo)體GaN和SiC�,它的熱導(dǎo)率和擊穿電場(chǎng)都不高�,因此它的功率特性方面的表現(xiàn)不足�����。為了滿足無(wú)線通信�����、雷達(dá)等應(yīng)用對(duì)高頻率、寬禁帶����、高效率、大功率器件的需要從二十世紀(jì)九十年代初開(kāi)始�����,化合物半導(dǎo)體電子器件的研究重心開(kāi)始轉(zhuǎn)向?qū)捊麕О雽?dǎo)體。
我們一般把禁帶寬度大于2eV的半導(dǎo)體稱為寬禁帶半導(dǎo)體�����。寬禁帶半導(dǎo)體材料具有寬帶隙、高臨界擊穿電場(chǎng)��、高熱導(dǎo)率�����、高載流子飽和漂移速度等特點(diǎn),在高溫���、高頻��、大功率、光電子及抗輻射等方面具有巨大的應(yīng)用潛力����。
1.2主要的寬禁帶半導(dǎo)體材料
近年來(lái)���,發(fā)展較好的寬禁帶半導(dǎo)體材料主要是SiC和GaN�����,其中SiC的發(fā)展更早一些�����,碳化硅、氮化鎵�����、硅以及砷化鎵的一些參數(shù)如下圖所示:

如上圖所示���,SiC和GaN的禁帶寬度遠(yuǎn)大于Si和GaAs,相應(yīng)的本征載流子濃度小于硅和砷化鎵����,寬禁帶半導(dǎo)體的最高工作溫度要高于第一、第二代半導(dǎo)體材料。擊穿場(chǎng)強(qiáng)和飽和熱導(dǎo)率也遠(yuǎn)大于硅和砷化鎵���。
2.1SiC材料
純碳化硅是無(wú)色透明的晶體。工業(yè)碳化硅因所含雜質(zhì)的種類和含量不同�����,而呈淺黃、綠、藍(lán)乃至黑色����,透明度隨其純度不同而異����。碳化硅晶體結(jié)構(gòu)分為六方或菱面體的α-SiC和立方體的β-SiC(稱立方碳化硅)�����。α-SiC由于其晶體結(jié)構(gòu)中碳和硅原子的堆垛序列不同而構(gòu)成許多不同變體���,已發(fā)現(xiàn)70余種����。β-SiC于2100℃以上時(shí)轉(zhuǎn)變?yōu)?/span>α-SiC���。
SiC是IV-IV族二元化合物半導(dǎo)體,也是周期表IV族元素中唯一的一種固態(tài)化合物。構(gòu)成元素是Si和C,每種原子被四個(gè)異種原子所包圍,形成四面體單元(圖25a)。原子間通過(guò)定向的強(qiáng)四面體SP3鍵(圖25b)結(jié)合在一起,并有一定程度的極化����。SiC具有很強(qiáng)的離子共價(jià)鍵�����,離子性對(duì)鍵合的貢獻(xiàn)約占12%,決定了它是一種結(jié)合穩(wěn)定的結(jié)構(gòu)。SiC具有很高的德拜溫度,達(dá)到1200-1430K,決定了該材料對(duì)于各種外界作用的穩(wěn)定性���,在力學(xué)、化學(xué)方面有優(yōu)越的技術(shù)特性。它的多型結(jié)構(gòu)如圖所示:
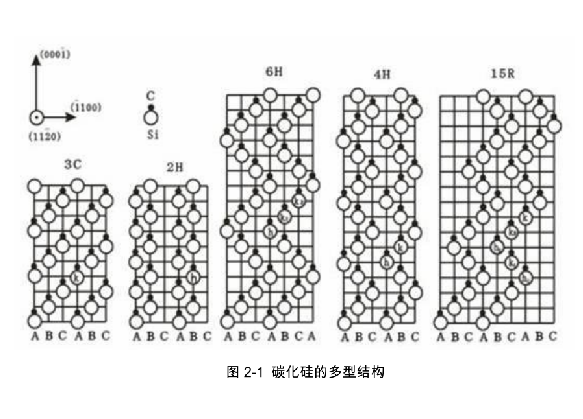
碳化硅由于化學(xué)性能穩(wěn)定、導(dǎo)熱系數(shù)高�����、熱膨脹系數(shù)小�、耐磨性能好���,除作磨料用外�����,還有很多其他用途����,例如:以特殊工藝把碳化硅粉末涂布于水輪機(jī)葉輪或汽缸體的壁,可提高其耐磨性而延長(zhǎng)使用壽命1~2倍;用以制成的高級(jí)耐火材料,耐熱震��、體積小�、重量輕而強(qiáng)度高���,節(jié)能效果好��。低品級(jí)碳化硅(含SiC約85%)是極好的脫氧劑,用它可加快煉鋼速度,并便于控制化學(xué)成分�����,提高鋼的質(zhì)量。此外�,碳化硅還大量用于制作電熱元件硅碳棒。
碳化硅的硬度很大,莫氏硬度為9.5級(jí),僅次于世界上最硬的金剛石(10級(jí))����,具有優(yōu)良的導(dǎo)熱性能����,是一種半導(dǎo)體,高溫時(shí)能抗氧化。
2.2GaN材料
GaN是一種極穩(wěn)定��,堅(jiān)硬的高熔點(diǎn)材料���,熔點(diǎn)約為1700℃。GaN具有高的電離度,在Ⅲ—Ⅴ族化合物中是最高的(0.5或0.43)��。在大氣壓下�,GaN晶體一般是六方纖鋅礦結(jié)構(gòu)。它在一個(gè)晶胞中有4個(gè)原子。因?yàn)槠溆捕雀?,又可以作為良好的涂層保護(hù)材料�。
在室溫下,GaN不溶于水�、酸和堿,而在熱的堿溶液中溶解速度又非常緩慢���。但是NaOH、H2SO4和H3PO4能較快地腐蝕質(zhì)量差的GaN,這種方法可以用來(lái)檢測(cè)質(zhì)量不高的GaN晶體。GaN在HCL或H2氣氛高溫下呈現(xiàn)不穩(wěn)定特性����,而在N2氣下最為穩(wěn)定�。GaN基材料是直接躍遷型半導(dǎo)體材料,具有優(yōu)良的光學(xué)性能,可作出高效率的發(fā)光器件,GaN基LED的發(fā)光波長(zhǎng)圍可從紫外到綠色光
Ⅲ族氮化物主要包括GaN�����、ALN��、InN����、ALInN�����、GaInN、ALInN和ALGaInN等�����,其禁帶寬度覆蓋了紅、黃、綠�����、藍(lán)�、紫和紫外光譜圍。GaN是Ⅲ族氮化物中的基本材料��,也是目前研究最多的Ⅲ族氮化物材料�����。GaN的電學(xué)性質(zhì)是決定器件性能的主要因素����。目前GaN的電子室溫遷移率可以達(dá)到900cm2/(V*s)。GaN材料所具有的禁帶寬度大��、擊穿電場(chǎng)高�、電子飽和速度高是制作高溫���、大功率器件的最佳材料�。
氮化物半導(dǎo)體材料存在六方纖鋅礦和立方閃鋅礦兩種不同的晶體結(jié)構(gòu)����,如氮化鎵的結(jié)構(gòu)下圖所示:

晶體結(jié)構(gòu)的形成主要由晶體的離子性決定�����,氮化物的離子性強(qiáng),所以纖鋅礦是氮化鎵的常見(jiàn)結(jié)構(gòu),閃鋅礦結(jié)構(gòu)是亞穩(wěn)態(tài)結(jié)構(gòu)�����。
GaN材料系列具有低的熱產(chǎn)生率和高的擊穿電場(chǎng)���,是研制高溫大功率電子器件和高頻微波器件的重要材料�����。目前�����,隨著MBE技術(shù)在GaN材料應(yīng)用中的進(jìn)展和關(guān)鍵薄膜生長(zhǎng)技術(shù)的突破,成功地生長(zhǎng)出了GaN多種異質(zhì)結(jié)構(gòu)����。用GaN材料制備出了金屬場(chǎng)效應(yīng)晶體管(MESFET)�����、異質(zhì)結(jié)場(chǎng)效應(yīng)晶體管(HFET)、調(diào)制摻雜場(chǎng)效應(yīng)晶體管(MODFET)等新型器件�。調(diào)制摻雜的AlGaN/GaN結(jié)構(gòu)具有高的電子遷移率(2000cm2/v·s)��、高的飽和速度(1×107cm/s)���、較低的介電常數(shù)��,是制作微波器件的優(yōu)先材料����;GaN較寬的禁帶寬度(3.4eV)及藍(lán)寶石等材料作襯底,散熱性能好,有利于器件在大功率條件下工作。
對(duì)于GaN材料���,長(zhǎng)期以來(lái)還有襯底單晶,異質(zhì)外延缺陷密度相當(dāng)高等問(wèn)題還沒(méi)有解決,但是GaN半導(dǎo)體器件的水平已可實(shí)用化。InGaN系合金的生成,InGaN/AlGaN雙質(zhì)結(jié)LED�,InGaN單量子阱LED��,InGaN多量子阱LED等相繼開(kāi)發(fā)成功。InGaN與AlGaP��、AlGaAs系紅色LED組合形成亮亮度全色顯示����。這樣三原色混成的白色光光源也打開(kāi)新的應(yīng)用領(lǐng)域,以高可靠����、長(zhǎng)壽命LED為特征的時(shí)代就會(huì)到來(lái)�����。日光燈和電燈泡都將會(huì)被LED所替代���。LED將成為主導(dǎo)產(chǎn)品��,GaN晶體管也將隨材料生長(zhǎng)和器件工藝的發(fā)展而迅猛發(fā)展,成為新一代高溫度頻大功率器件�。
3.1寬禁帶半導(dǎo)體的工藝
氧化工藝
SiC的氧化層與硅器件制作中的SiO2具有十分相似的作用���,例如氧化層作為工藝過(guò)程的掩膜,用作金屬-氧化物-半導(dǎo)體(MOS)結(jié)構(gòu)的絕緣層�、作為器件表面的電學(xué)鈍化層等。外延生長(zhǎng)前的氧化過(guò)程還可以除去SiC襯底上的拋光損傷�����。由于SiC可以被氧化成SiO2�����,因此器件制作中可以與成熟的硅器件平面工藝相兼容����。實(shí)現(xiàn)熱氧化不需要特殊的不同于在硅上獲得SiO2時(shí)所利用的工藝設(shè)備���,它們的區(qū)別僅僅是碳化硅的氧化速度明顯減少,采用干氧氧化和濕氧氧化進(jìn)行熱氧化,還可以在N2O中獲得SiO2�,可使用氮化物或氮氧化物絕緣體應(yīng)用于高溫器件�。
熱氧化法主要包括干氧氧化和濕氧氧化���,干氧氧化:Si+O2→SiO2��,它的優(yōu)點(diǎn)是結(jié)構(gòu)致密、干燥��、均勻性和重復(fù)性好�,掩蔽能力強(qiáng),與光刻膠黏附性好����,也是一種理想的鈍化膜。高質(zhì)量SiO2薄膜如MOS柵氧化層一般都采用此法制備����。濕氧氧化:氧化劑是通過(guò)高純水(一般被加熱到950C左右)的氧氣���,既有氧又有水。氧化速度介于干氧和水汽氧化之間��,具體與氧氣流量����、水汽含量等有關(guān)也可用惰性氣體(氮?dú)饣驓鍤猓y帶水汽進(jìn)行氧化熱氧化的優(yōu)點(diǎn):質(zhì)量好��,表面態(tài)密度小����,可很好控制界面陷阱和固定電荷,性質(zhì)不太受濕度和中等熱處理溫度的影響,因此是集成電路中最重要的制備SiO2方法�����。
3.2光刻
光刻是集成電路工藝中的關(guān)鍵性技術(shù)����,最早的構(gòu)想來(lái)源于印刷技術(shù)中的照相制版�。它的概念是將掩模版上的圖形(電路結(jié)構(gòu))“臨時(shí)”(嵌套式)轉(zhuǎn)移到硅片上的過(guò)程。光刻技術(shù)在半導(dǎo)體器件制造中的應(yīng)用最早可追溯到1958年����,實(shí)現(xiàn)了平面晶體管的制作。光刻工藝的成本在整個(gè)IC芯片加工成本中幾乎占三分之一�,IC集成度的提高,主要?dú)w功用于光刻技術(shù)的進(jìn)步��。
集成電路中對(duì)光刻的基本要求:
(1)高分辯率�����。通常把線寬作為光刻水平的標(biāo)志��,也用加工圖形線寬的能力來(lái)代表IC的工藝水平�。
(2)高靈敏度的光刻膠(指膠的感光速度)����。為了提高IC產(chǎn)量�����,希望曝光時(shí)間越短越好。
(3)低缺陷。在光刻中引入的缺陷的影響比其它工藝更嚴(yán)重,比如重復(fù)導(dǎo)致多數(shù)片子都變壞���。
(4)精密的套刻對(duì)準(zhǔn)��。允許的套刻誤差為線寬的10%��。
(5)對(duì)大尺寸硅片的加工�。在大尺寸硅片上滿足上述光刻要求的難度更大���。
光刻工藝的主要步驟圖如下:

光刻的主要步驟:
(1)涂膠(甩膠):在硅片表面形成厚度均勻�����、附著性強(qiáng)���、沒(méi)有缺陷的光刻膠薄膜��。之前需要脫水烘焙,并且涂上HMDS或TMSDEA用以增加光刻膠與硅片表面的附著能力
(2)前烘:去溶劑��,減少灰塵污染�,保持曝光精確度���,減少顯影溶解致厚度損失���,減輕高速旋轉(zhuǎn)致薄膜應(yīng)力。由于前烘��,光刻膠的厚度會(huì)減薄10%~20%
(3)曝光:光刻膠通過(guò)掩模曝光����,以正膠為例�����,感光劑DQ受光變?yōu)橐蚁┩?,再變?yōu)轸人幔ㄒ兹苡趬A液)
(4)顯影:正膠的曝光區(qū)和負(fù)膠的非曝光區(qū)在顯影液中溶解����,使曝光后光刻膠層中形成的潛在圖形顯現(xiàn)出來(lái)�。圖形檢查,不合格的返工,用丙酮去膠
(5)堅(jiān)膜:高溫處理過(guò)程,除去光刻膠中的剩余溶液�����,增加附著力,提高抗蝕能力��。堅(jiān)膜溫度(光刻膠玻璃態(tài)轉(zhuǎn)變溫度)高于前烘和曝光后烘烤溫度����,在這個(gè)溫度下���,光刻膠將軟化�����,表面在表面力的作用下而圓滑化��,減少光刻膠層中的缺陷�,并修正光刻膠圖形的邊緣輪廓
(6)刻蝕或注入
(7)去膠:將光刻膠從硅片的表面除去��,包括干法去膠和濕法去膠��。干法去膠就是用等離子體(如氧等離子體)將光刻膠剝除。濕法去膠又分為有機(jī)溶劑(常用丙酮)去膠和無(wú)機(jī)溶劑(如H2SO4和H2O2)去膠�����,而金屬化后必須用有機(jī)溶劑去膠�����。干法去膠和濕法去膠經(jīng)常搭配進(jìn)行�。
以在SiO2氧化膜上光刻為例,如下圖���,首先在有SiO2覆蓋的硅片表面涂布一層對(duì)紫外光敏感材料�����,這種材料是一種液態(tài)物質(zhì)叫做光刻膠。將少量液態(tài)光刻膠滴在硅片上���,再經(jīng)過(guò)高速旋轉(zhuǎn)后�,則在硅片表面形成一層均勻的光刻膠薄膜���。甩膠之后��,在較低的溫度(80oC-100oC)下進(jìn)行一定時(shí)間烘焙���,其目的是,使光刻膠中的溶劑揮發(fā),從而改善光刻膠與表面的粘附性����。硬化后的光刻膠與照像所使用的感光膠相似����。
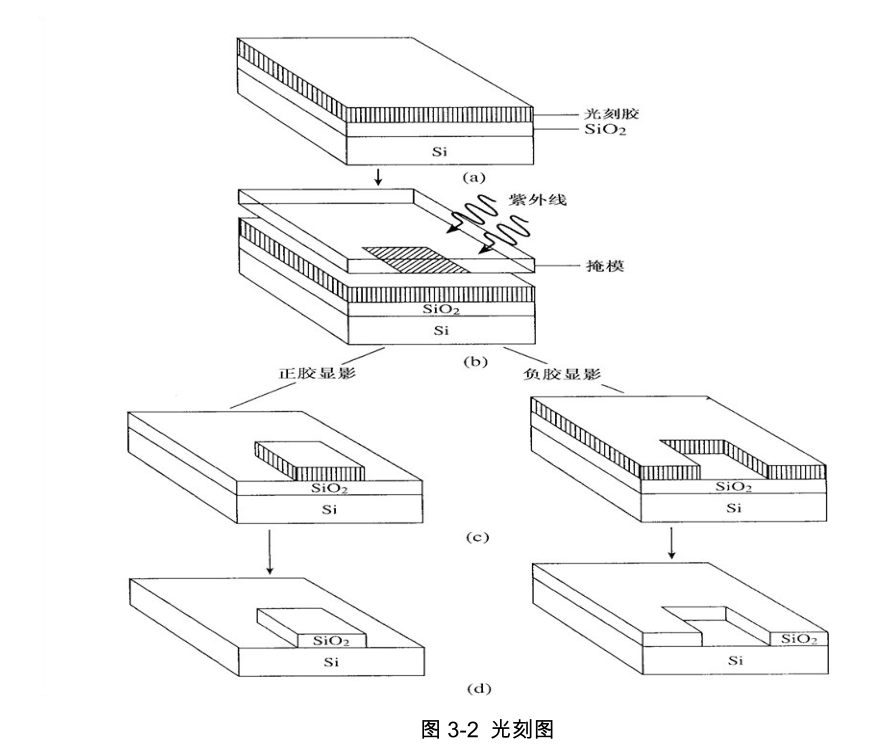
接下來(lái)用UV光通過(guò)掩模版的透光區(qū)使光刻膠曝光����,如圖(b)所示����。掩模版是預(yù)先制備的玻璃或石英版�,其上復(fù)制有需要轉(zhuǎn)移到SiO2薄膜上的圖形���。掩模版的暗區(qū)可以阻擋UV光線通過(guò)。曝光區(qū)域中的光刻膠會(huì)發(fā)生光化學(xué)反應(yīng),反應(yīng)的類型與光刻膠的種類有關(guān)。對(duì)于負(fù)性光刻膠���,在經(jīng)過(guò)光照的區(qū)域會(huì)發(fā)生聚合反應(yīng)��,變得難以去除��。浸入顯影劑之后�����,曝光區(qū)域發(fā)生聚合反應(yīng)的負(fù)膠保留下來(lái),而沒(méi)有曝光的區(qū)域的負(fù)膠被分解掉����,溶于顯影液中��。經(jīng)過(guò)顯影之后的負(fù)膠圖形如圖(c)的右圖所示����。正性光刻膠中含有大量的感光劑,可以顯著地抑制正膠在堿性顯影液中的溶解速度。經(jīng)過(guò)曝光之后���,感光劑發(fā)生分解�,使得曝光區(qū)域的正
膠被優(yōu)先除去,其效果如圖(c)的左圖所示�����。從應(yīng)用的過(guò)程來(lái)看�����,負(fù)膠在早期的IC工藝中廣泛應(yīng)用。現(xiàn)在正膠的應(yīng)用已經(jīng)成為主流��,因?yàn)檎z可以提供更好的圖形控制�����。
對(duì)準(zhǔn)方法:
(1)預(yù)對(duì)準(zhǔn)���,通過(guò)硅片上的notch或者flat進(jìn)行激光自動(dòng)對(duì)準(zhǔn)���;
(2)通過(guò)對(duì)準(zhǔn)標(biāo)志(AlignMark)���,位于切割槽(ScribeLine)上����。另外層間對(duì)準(zhǔn),即套刻精度(Overlay)�����,保證圖形與硅片上已經(jīng)存在的圖形之間的對(duì)準(zhǔn)。曝光中最重要的兩個(gè)參數(shù)是:曝光能量(Energy)和焦距(Focus)����。如果能量和焦距調(diào)整不好��,就不能得到要求的分辨率和大小的圖形�����。表現(xiàn)為圖形的關(guān)鍵尺寸超出要求的圍���。
曝光方法:
(1)接觸式曝光(ContactPrinting)�����。掩膜板直接與光刻膠層接觸�。曝光出來(lái)的圖形與掩膜板上的圖形分辨率相當(dāng)���,設(shè)備簡(jiǎn)單。缺點(diǎn):光刻膠污染掩膜板;掩膜板的磨損����,壽命很低(只能使用5~25次)���;1970前使用,分辨率〉0.5μm。
(2)接近式曝光(ProximityPrinting)�����。掩膜板與光刻膠層的略微分開(kāi)�����,大約為10~50μm��??梢员苊馀c光刻膠直接接觸而引起的掩膜板損傷����。但是同時(shí)引入了衍射效應(yīng)�,降低了分辨率����。1970后適用,但是其最大分辨率僅為2~4μm��。
(3)投影式曝光(ProjectionPrinting)����。在掩膜板與光刻膠之間使用透鏡聚集光實(shí)現(xiàn)曝光。一般掩膜板的尺寸會(huì)以需要轉(zhuǎn)移圖形的4倍制作����。優(yōu)點(diǎn):提高了分辨率;掩膜板的制作更加容易��;掩膜板上的缺陷影響減小�����。
投影式曝光分類:
掃描投影曝光(ScanningProjectPrinting)�。70年代末~80年代初���,〉1μm工藝�;掩膜板1:1,全尺寸步進(jìn)重復(fù)投影曝光(Stepping-repeatingProjectPrinting或稱作Stepper)����。80年代末~90年代,0.35μm(Iline)~0.25μm(DUV)。掩膜板縮小比例(4:1)���,曝光區(qū)域(ExposureField)22×22mm(一次曝光所能覆蓋的區(qū)域)�。增加了棱鏡系統(tǒng)的制作難度���。掃描步進(jìn)投影曝光(Scanning-SteppingProjectPrinting)��。90年代末~至今,用于≤0.18μm工藝�。采用6英寸的掩膜板按照4:1的比例曝光��,曝光區(qū)域(ExposureField)26×33mm。優(yōu)點(diǎn):增大了每次曝光的視場(chǎng)����;提供硅片表面不平整的補(bǔ)償��;提高整個(gè)硅片的尺寸均勻性�����。但是��,同時(shí)因?yàn)樾枰聪蜻\(yùn)動(dòng)�,增加了機(jī)械系統(tǒng)的精度要求。
在曝光過(guò)程中����,需要對(duì)不同的參數(shù)和可能缺陷進(jìn)行跟蹤和控制��,會(huì)用到檢測(cè)控制芯片/控片(MonitorChip)。根據(jù)不同的檢測(cè)控制對(duì)象�����,可以分為以下幾種:
(1)顆?���?仄?/span>ParticleMC):用于芯片上微小顆粒的監(jiān)控�����,使用前其顆粒數(shù)應(yīng)小于10顆;
(2)卡盤顆?���?仄?/span>ChuckParticleMC):測(cè)試光刻機(jī)上的卡盤平坦度的專用芯片�����,其平坦度要求非常高�;
(3)焦距控片(FocusMC):作為光刻機(jī)監(jiān)控焦距監(jiān)控���;
(4)關(guān)鍵尺寸控片(CriticalDimensionMC):用于光刻區(qū)關(guān)鍵尺寸穩(wěn)定性的監(jiān)控;
(5)光刻膠厚度控片(PhotoResistThicknessMC):光刻膠厚度測(cè)量��;
(6)光刻缺陷控片(PDM,PhotoDefectMonitor):光刻膠缺陷監(jiān)控。舉例:0.18μm的CMOS掃描步進(jìn)光刻工藝�。
光源:KrF氟化氪DUV光源(248nm);數(shù)值孔徑NA:0.6~0.7�;焦深DOF:0.7μm分辨率Resolution:0.18~0.25μm(一般采用了偏軸照明OAI_Off-AxisIllumination和相移掩膜板技術(shù)PSM_PhaseShiftMask增強(qiáng))����;套刻精度Overlay:65nm�;產(chǎn)能Throughput:30~60wafers/hour(200mm);視場(chǎng)尺寸FieldSize:25×32mm��;
顯影方法:
(1)整盒硅片浸沒(méi)式顯影(BatchDevelopment)。缺點(diǎn):顯影液消耗很大�;顯影的均勻性差�����;
(2)連續(xù)噴霧顯影(ContinuousSprayDevelopment)�。
自動(dòng)旋轉(zhuǎn)顯影(Auto-rotationDevelopment)���。一個(gè)或多個(gè)噴嘴噴灑顯影液在硅片表面���,同時(shí)硅片低速旋轉(zhuǎn)(100~500rpm)。噴嘴噴霧模式和硅片旋轉(zhuǎn)速度是實(shí)現(xiàn)硅片間溶解率和均勻性的可重復(fù)性的關(guān)鍵調(diào)節(jié)參數(shù)��。
(3)水坑(旋覆浸沒(méi))式顯影(PuddleDevelopment)��。
噴覆足夠(不能太多���,最小化背面濕度)的顯影液到硅片表面���,并形成水坑形狀(顯影液的流動(dòng)保持較低�,以減少邊緣顯影速率的變化)。硅片固定或慢慢旋轉(zhuǎn)��。一般采用多次旋覆顯影液:第一次涂覆、保持10~30秒���、去除;第二次涂覆、保持���、去除�����。然后用去離子水沖洗(去除硅片兩面的所有化學(xué)品)并旋轉(zhuǎn)甩干��。優(yōu)點(diǎn):顯影液用量少;硅片顯影均勻�����;最小化了溫度梯度�。
顯影液:
(1)正性光刻膠的顯影液�。正膠的顯影液位堿性水溶液�。KOH和NaOH因?yàn)闀?huì)帶來(lái)可動(dòng)離子污染(MIC�,MovableIonContamination),所以在IC制造中一般不用����。最普通的正膠顯影液是四甲基氫氧化銨(TMAH)(標(biāo)準(zhǔn)當(dāng)量濃度為0.26��,溫度15~250C)���。在I線光刻膠曝光中會(huì)生成羧酸��,TMAH顯影液中的堿與酸中和使曝光的光刻膠溶解于顯影液,而未曝光的光刻膠沒(méi)有影響�;在化學(xué)放大光刻膠(CAR�,ChemicalAmplifiedResist)中包含的酚醛樹(shù)脂以PHS形式存在��。CAR中的PAG產(chǎn)生的酸會(huì)去除PHS中的保護(hù)基團(tuán)(t-BOC)���,從而使PHS快速溶解于TMAH顯影液中����。整個(gè)顯影過(guò)程中,TMAH沒(méi)有同PHS發(fā)生反應(yīng)。
(2)負(fù)性光刻膠的顯影液��。顯影液為二甲苯。清洗液為乙酸丁脂或乙醇、
三氯乙烯�����。
顯影中的常見(jiàn)問(wèn)題:
(1)顯影不完全(IncompleteDevelopment)��。表面還殘留有光刻膠����。顯影液不足造成;
(2)顯影不夠(UnderDevelopment)����。顯影的側(cè)壁不垂直�,由顯影時(shí)間不足造成�����;
(3)過(guò)度顯影(OverDevelopment)?��?拷砻娴墓饪棠z被顯影液過(guò)度溶解����,形成臺(tái)階。顯影時(shí)間太長(zhǎng)��。
3.3刻蝕
刻蝕是指用化學(xué)或物理方法有選擇地從硅片表面去除不需要的材料的過(guò)程。刻蝕的基本目的��,是在涂膠(或有掩膜)的硅片上正確的復(fù)制出掩膜圖形����。通常是在光刻工藝之后進(jìn)行�。我們通常通過(guò)刻蝕�����,在光刻工藝之后,將想要的圖形留在硅片上���。從這一角度而言���,刻蝕可以被稱之為最終的和最主要的圖形轉(zhuǎn)移工藝步驟�����。在通常的刻蝕過(guò)程中��,有圖形的光刻膠層〔或掩膜層)將不受到腐蝕源顯著的侵蝕或刻蝕�,可作為掩蔽膜��,保護(hù)硅片上的部分特殊區(qū)域,而未被光刻膠保護(hù)的區(qū)域�����,則被選擇性的刻蝕掉。
在半導(dǎo)體制造中有兩種基本的刻蝕工藝:干法刻蝕和濕法腐蝕�����。
干法刻蝕�,是利用氣態(tài)中產(chǎn)生的等離子體���,通過(guò)經(jīng)光刻而開(kāi)出的掩蔽層窗口����,與暴露于等離子體中的硅片行物理和化學(xué)反應(yīng),刻蝕掉硅片上暴露的表面材料的一種工藝技術(shù)法���。該工藝技術(shù)的突出優(yōu)點(diǎn)在于,可以獲得極其精確的特征圖形��。超大規(guī)模集成電路的發(fā)展�,要求微細(xì)化加工工藝能夠嚴(yán)格的控制加工尺寸,要求在硅片上完成極其精確的圖形轉(zhuǎn)移�。任何偏離工藝要求的圖形或尺寸�,都可能直接影響產(chǎn)品性能或品質(zhì)���,給生產(chǎn)帶來(lái)無(wú)法彌補(bǔ)的損害���。由于干法刻蝕技術(shù)在圖形軼移上的突出表現(xiàn)����,己成為亞微米尺寸下器件刻蝕的最主要工藝方法����。在特征圖形的制作上����,已基本取代了濕法腐蝕技術(shù)。
對(duì)于濕法腐蝕��,就是用液體化學(xué)試劑(如酸、堿和溶劑等)以化學(xué)的方式去除硅片表面的材料��。當(dāng)然����,在通過(guò)濕法腐蝕獲得特征圖形時(shí)�����,也要通過(guò)經(jīng)光刻開(kāi)出的掩膜層窗口����,腐蝕掉露出的表面材料�����。但從控制圖形形狀和尺寸的準(zhǔn)確性角度而言�,在形成特征圖形方面���,濕法腐蝕一般只被用于尺寸較大的情況(大于3微米)。由于這一特點(diǎn)�,濕法腐蝕遠(yuǎn)遠(yuǎn)沒(méi)有干法刻蝕的應(yīng)用廣泛。但由于它的高選擇比和批量制作模式���,濕法腐蝕仍被廣泛應(yīng)用在腐蝕層間膜�����、去除干法刻蝕殘留物和顆粒等工藝步驟中。