
掃碼添加微信���,獲取更多濕法工藝資料
缺陷掃描檢查
? ?在開(kāi)始生產(chǎn)之前,裸晶圓在晶圓制造商處要檢驗(yàn)合格合格�����,并在半導(dǎo)體工廠接收后再次要檢驗(yàn)合格�。只有最無(wú)缺陷的晶圓才用于生產(chǎn),它們的生產(chǎn)前缺陷圖允許制造商跟蹤可能導(dǎo)致芯片功能不佳的區(qū)域�。裸晶片或非圖案化晶片也在經(jīng)受被動(dòng)或主動(dòng)處理環(huán)境之前和之后被測(cè)量,以確定來(lái)自給定處理工具的粒子貢獻(xiàn)的基線���。

圖1:旋轉(zhuǎn)非圖案化晶片上的缺陷檢測(cè)(左)以及暗場(chǎng)和亮場(chǎng)圖像照明中鏡面反射的使用(右)
? ?器件制造商使用光學(xué)檢測(cè)系統(tǒng)來(lái)檢查晶片和掩模上的顆粒和其他類(lèi)型的缺陷���,并確定這些缺陷在晶片上的X-Y網(wǎng)格中的位置。用于非圖案化晶片上的缺陷檢測(cè)的基本原理相對(duì)簡(jiǎn)單����。激光束在旋轉(zhuǎn)的晶片表面上徑向掃描��,以確保光束投射到晶片表面的所有部分上���。激光從表面反射,就像從鏡子反射一樣���,如圖1所示�����。這種反射被稱(chēng)為鏡面反射。當(dāng)激光束遇到晶片表面上的顆?��;蚱渌毕輹r(shí)����,缺陷散射一部分激光���。根據(jù)照明布置�����,散射光可以被直接檢測(cè)(暗場(chǎng)照明)或作為反射光束中強(qiáng)度的損失(亮場(chǎng)照明)����。晶片的旋轉(zhuǎn)位置和光束的徑向位置限定了晶片表面上缺陷的位置。在晶圓檢測(cè)工具中�,使用光電倍增管或電荷耦合器件以電子方式記錄光強(qiáng)度,并生成晶圓表面的散射或反射強(qiáng)度圖�����,如圖2所示���。該圖提供了有關(guān)缺陷大小和位置的信息���,以及由于顆粒污染等問(wèn)題造成的晶片表面狀況的信息。這種方法需要對(duì)晶片臺(tái)和光學(xué)元件進(jìn)行高度精確和可重復(fù)的旋轉(zhuǎn)和線性運(yùn)動(dòng)控制��。
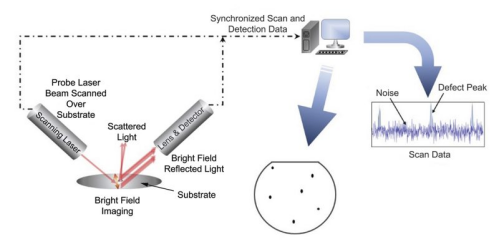
?
圖2:檢查工具中的光收集����、處理和晶片映射
? ?一般來(lái)說(shuō),暗場(chǎng)檢查對(duì)于非圖案化晶片檢查是優(yōu)選的���,因?yàn)楦吖鈻呕俣仁强赡艿?����,并且這能夠?qū)崿F(xiàn)高晶片產(chǎn)量�。圖案化晶圓檢測(cè)是一個(gè)慢得多的過(guò)程。根據(jù)應(yīng)用���,它可以使用明場(chǎng)和/或暗場(chǎng)成像�����。請(qǐng)注意��,圖案化表面散射的復(fù)雜性降低了到達(dá)檢測(cè)器的總光子通量����,導(dǎo)致晶圓檢測(cè)的積分周期更長(zhǎng)�����。
100納米以下的檢測(cè)工具目前被用于制造環(huán)境中����,以保證進(jìn)入晶圓的質(zhì)量���,并用于大批量制造的工藝工具監(jiān)控和鑒定����。這些工具采用與設(shè)計(jì)用于大規(guī)模缺陷檢測(cè)的工具相同的基本操作原理,但使用DUV照明增強(qiáng)光學(xué)系統(tǒng)��。一些制造商聲稱(chēng)復(fù)雜的圖像分析算法可以達(dá)到20納米以下的靈敏度�����。正如所料����,在這些應(yīng)用中使用的系統(tǒng)中,晶片臺(tái)和光學(xué)部件的運(yùn)動(dòng)控制需要高度的精度和準(zhǔn)確度���。
? ? ? 由于需要檢測(cè)工具來(lái)檢測(cè)和量化越來(lái)越小的顆粒�����,由于散射光信號(hào)的信噪比降低�,表面微粗糙度(霧度)等因素的影響開(kāi)始影響小顆粒的可檢測(cè)性���。非圖案化晶片的亞100納米檢測(cè)由于尺度問(wèn)題而變得復(fù)雜�����,信噪比是確定檢測(cè)系統(tǒng)對(duì)晶片表面顆粒和其他缺陷的檢測(cè)極限的關(guān)鍵參數(shù)����。來(lái)自環(huán)境濕度等來(lái)源的表面化學(xué)污染也會(huì)導(dǎo)致信噪比下降。為了幫助抵消這種影響�,用于亞100納米缺陷檢測(cè)的檢測(cè)工具采用高度復(fù)雜的光學(xué)空間濾波、散射信號(hào)的偏振分析和專(zhuān)門(mén)的信號(hào)處理算法來(lái)檢測(cè)存在表面霧度的缺陷�。
形貌檢查
? ? ? 測(cè)量裸晶片形貌有許多原因。例如��,晶片可能彎曲�����,或者支撐晶片的卡盤(pán)(靜電或氣動(dòng))可能在晶片的接觸點(diǎn)產(chǎn)生凹痕��。這種變形會(huì)影響納米尺度的圖案成像�。已經(jīng)開(kāi)發(fā)出非常精確的干涉測(cè)量工具來(lái)測(cè)量加工前晶片形狀的這種變化���。
用于測(cè)量裸晶圓表面形貌的基本設(shè)計(jì)類(lèi)似于圖3所示的斐索干涉儀���。這種干涉測(cè)量技術(shù)將晶片與非常高質(zhì)量和平整度的參考楔(或參考平面)進(jìn)行比較���。楔角確保來(lái)自平面的第一表面的反射不會(huì)對(duì)干涉信號(hào)產(chǎn)生影響。從第二表面反射的光用作參考����,同時(shí)一部分光穿過(guò)平板以詢問(wèn)晶片(測(cè)試平板)。從晶片和測(cè)試平臺(tái)反射的光被分束器導(dǎo)向成像系統(tǒng)��。分析干涉圖案�����,并使用軟件將測(cè)量結(jié)果拼接在一起,以形成具有納米尺度分辨率的完整晶片圖�。實(shí)際上,測(cè)量裸晶片形貌的干涉測(cè)量工具極其復(fù)雜����,并且利用運(yùn)動(dòng)解決方案��、大型光學(xué)器件和照明源來(lái)幫助擴(kuò)展可制造性設(shè)計(jì)的邊界�����。

圖3
差分圖像檢測(cè)
? ? ? ?圖案化晶片的光學(xué)檢查可以采用明場(chǎng)照明、暗場(chǎng)照明或兩者的組合來(lái)進(jìn)行缺陷檢測(cè)�。圖案化晶片檢測(cè)系統(tǒng)將晶片上測(cè)試管芯的圖像與相鄰管芯(或已知無(wú)缺陷的“金”管芯)的圖像進(jìn)行比較。圖像處理軟件從一幅圖像中減去另一幅圖像���。其中一個(gè)芯片中的任何隨機(jī)缺陷都不會(huì)在相減過(guò)程中歸零�����,在相減后的圖像中清晰顯示(圖4)���。缺陷的位置允許在晶片上生成缺陷圖,類(lèi)似于為非圖案化晶片生成的圖���。與非圖案化晶片的檢查一樣���,圖案化晶片檢查需要晶片臺(tái)和檢查系統(tǒng)的光學(xué)部件的精確和可重復(fù)的運(yùn)動(dòng)控制,因?yàn)樗鼈兺瑫r(shí)移動(dòng)�����。
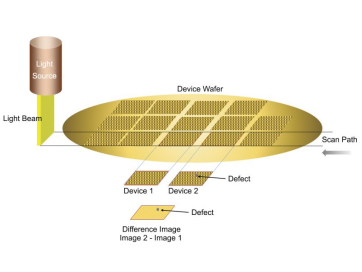
?
圖4:圖案化晶片檢查程序
亞100納米特征的DUV晶圓檢測(cè)
? ? 亞100納米圖案化晶片的缺陷檢測(cè)比非圖案化晶片檢測(cè)面臨更大的挑戰(zhàn)���。用于圖案化晶片應(yīng)用的基于DUV的光學(xué)檢測(cè)使用與舊的可見(jiàn)光和紫外光檢測(cè)系統(tǒng)相同的圖像比較原理。然而,基于DUV的方法在光學(xué)��、運(yùn)動(dòng)控制和圖像分析算法方面需要更高的復(fù)雜程度�����。
DUV檢測(cè)工具已成為圖案化晶圓檢測(cè)的行業(yè)標(biāo)準(zhǔn)��,其特征尺寸可達(dá)65納米����;高達(dá)每小時(shí)幾個(gè)晶片的檢查速率使得這些系統(tǒng)適合于生產(chǎn)應(yīng)用。DUV檢測(cè)工具顯示出對(duì)缺陷檢測(cè)的高靈敏度��,例如淺溝槽隔離空隙����、接觸蝕刻缺陷和亞100納米幾何形狀的光刻膠微橋接。使用寬帶DUV/紫外/可見(jiàn)照明�����,現(xiàn)代明場(chǎng)圖案化晶圓檢測(cè)系統(tǒng)目前可實(shí)現(xiàn)對(duì)動(dòng)態(tài)隨機(jī)存取存儲(chǔ)器和閃存器件上所有層缺陷檢測(cè)所需的靈敏度��,最低可達(dá)55納米特征尺寸��。
雖然眾所周知的特性加上相對(duì)較低的成本和較高的吞吐量使得DUV光學(xué)檢測(cè)系統(tǒng)的持續(xù)使用具有吸引力,但一些制造商報(bào)告稱(chēng)�����,DUV檢測(cè)系統(tǒng)不具備65納米以下幾何形狀所需的精度和靈敏度����。一項(xiàng)研究聲稱(chēng),DUV暗場(chǎng)光學(xué)圖案檢測(cè)系統(tǒng)的極限缺陷靈敏度在存儲(chǔ)技術(shù)(例如靜態(tài)隨機(jī)存取存儲(chǔ)器)中約為75納米���,在邏輯區(qū)域中更大�����。DUV明場(chǎng)系統(tǒng)的極限靈敏度稍高�,靜態(tài)隨機(jī)存取存儲(chǔ)器約為50納米�,暗場(chǎng)系統(tǒng)的極限靈敏度則更高。此外�,使用DUV激光照射圖案化晶片上非常小且因此易碎的結(jié)構(gòu)產(chǎn)生了一些不尋常的問(wèn)題,例如表面材料的激光燒蝕���。這些問(wèn)題的解決方案可能在于將寬帶等離子體照明用于光學(xué)檢查系統(tǒng)(現(xiàn)有的DUV系統(tǒng)采用266納米波長(zhǎng)�����,并且正在轉(zhuǎn)向193納米照明)或者使用能夠生產(chǎn)的電子束檢查工具��。最近推出的基于等離子體產(chǎn)生的寬帶照明的檢測(cè)工具可用于生產(chǎn)環(huán)境�。聲稱(chēng)這些系統(tǒng)的分辨率低于10納米���,因?yàn)樵谶@種較小的尺度下�,較短的波長(zhǎng)提供了更精確的檢查����。
電子束晶圓檢測(cè)
? ?電子束成像也用于缺陷檢查,尤其是在光學(xué)成像效率較低的較小幾何形狀上�。電子束檢查可以提供比光學(xué)檢查系統(tǒng)分辨率動(dòng)態(tài)范圍大得多的材料對(duì)比度。然而���,電子束應(yīng)用受到測(cè)量速度慢的限制�����,這使得它主要用于R&D環(huán)境和新技術(shù)鑒定的工藝開(kāi)發(fā)����。新的電子束工具可用于10納米及以下節(jié)點(diǎn)的缺陷檢測(cè)應(yīng)用���,多電子束工具正在開(kāi)發(fā)中�����,具有多達(dá)100個(gè)柱或測(cè)量通道���。
標(biāo)線檢查
? ?掩模版是用精細(xì)特征圖案化的透射或反射投影掩模����,通常比晶片上期望的圖案尺寸大4-5倍��。它們與光學(xué)照明系統(tǒng)一起使用�����,作為晶片圖案化過(guò)程的一部分���,光學(xué)照明系統(tǒng)對(duì)圖案化的光進(jìn)行成像和去放大�����,以選擇性地顯影光致抗蝕劑���。
可以說(shuō)��,掩模版檢查遠(yuǎn)比無(wú)圖案或有圖案的晶片檢查更重要���。這是因?yàn)椋m然裸晶片或圖案化晶片上的單個(gè)缺陷有可能“殺死”一個(gè)器件�,但是掩模版上的單個(gè)未檢測(cè)到的缺陷會(huì)破壞成千上萬(wàn)個(gè)器件,因?yàn)槿毕輹?huì)在使用該掩模版處理的每個(gè)晶片上復(fù)制���。對(duì)于EUV來(lái)說(shuō),這個(gè)問(wèn)題由于圖案的更精細(xì)的分辨率����、薄保護(hù)膜的存在以及分劃板的反射設(shè)計(jì)而變得更加復(fù)雜。
? ? ? ? ?除了通常使用透射光而不是反射光來(lái)檢查掩模版之外����,掩模版檢查系統(tǒng)的工作原理與晶片檢查工具相同,并且具有相似的物理要求����。透射光用于定位紫外線不透明污漬和其他透射缺陷。掩模版檢查工具根據(jù)缺陷容差和/或特征尺寸�����,采用高分辨率成像光學(xué)器件和可見(jiàn)光或紫外光照明,以發(fā)現(xiàn)掩模版坯料或圖案化掩模版上的缺陷�。在掩模版制造過(guò)程中和整個(gè)掩模版使用過(guò)程中,例行檢查����。標(biāo)線檢查工具采用了類(lèi)似于晶片檢查工具中使用的復(fù)雜圖像分析軟件和運(yùn)動(dòng)控制系統(tǒng)。通過(guò)使用紫外線照明�����,傳統(tǒng)光學(xué)器件在標(biāo)線檢查系統(tǒng)中的使用已經(jīng)擴(kuò)展到90納米的特征尺寸��。使用電子束可以在較小的特征尺寸下進(jìn)行掩模版檢查�����,因?yàn)榕c圖案化晶片檢查相比�����,可以容許較低的生產(chǎn)量��。與晶片檢測(cè)一樣�����,亞100納米應(yīng)用中使用的掩模版檢測(cè)工具(空白和圖案化掩模版檢測(cè))采用DUV照明,通常使用266納米或193納米的單一波長(zhǎng)�����。
注意:此處包含的信息���、建議和意見(jiàn)僅供參考���,僅供您考慮,查詢和驗(yàn)證�����,不以任何方式 保證任何材料在特定下的的適用性����。華林科納CSE對(duì)以任何形式����、任何情況,任可應(yīng)用��、測(cè)試或交流使用提供的數(shù)據(jù)不承擔(dān)任何法法律表任,此處包含的任何內(nèi)容不得解釋為在任何專(zhuān)利下運(yùn)營(yíng)或侵如任何專(zhuān)利的 許可或授權(quán)���。