
掃碼添加微信��,獲取更多濕法工藝資料
平版印刷術被定義為“一種從已經準備好的平坦表面(如光滑的石頭或金屬板)印刷的方法,以便油墨僅粘附在將要印刷的設計上”����。在半導體器件制造中���,石頭是硅片����,而墨水是沉積�、光刻和蝕刻工藝的綜合效果�,從而產生所需的特征��。因為用于器件制造的光刻涉及使用光學曝光來創(chuàng)建圖案,所以半導體光刻通常被稱為“光刻”���。與已經討論的檢查和計量技術一樣����,光刻是圖案化的選擇技術,因為它是光學的���,因此能夠實現小特征和高晶片產量����。這與直接書寫和壓印等其他技術形成對比���。
光刻的基本原理
圖1示出了用于定義淺溝槽隔離特征的典型光刻工藝�����。這一過程包括以下步驟:
1.?基板清潔和準備
2.?形成熱氧化層����,并在干凈的襯底上沉積一層氮化硅
3.?沉積碳硬掩模,然后沉積一層抗反射材料
4.?沉積一層光刻膠
5.?預烘焙光刻膠
6.?對準襯底/光刻膠和掩模版���,使用紫外輻射和4x-5x成像曝光光刻膠���。重復步驟和掃描
7.?曝光后烘焙
8.?在光致抗蝕劑中顯影圖案����,并硬烘焙以去除剩余的溶劑
9.?執(zhí)行蝕刻以打開電介質抗反射涂層(DARC)和硬掩模圖案�,并去除光致抗蝕劑和DARC
10.?執(zhí)行蝕刻以在襯底中打開溝槽并去除硬掩模
11.?清潔表面
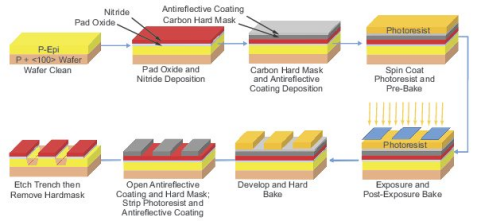 ?
?
? ? ? ? ? ? ? ? ? ? ? ?圖1?半導體器件構圖工藝的示意圖?
深紫外光刻
用于光刻的DUV技術完全基于投影光學���,因為光掩模上的圖案比光致抗蝕劑上形成的最終圖案大得多��。193納米光刻工具中的光學系統(tǒng)被稱為折反射系統(tǒng)�。該術語意味著它使用透鏡(折射)和反射(反射)元件來引導和調節(jié)來自激光器的光。更多信息�,請參見深紫外光刻。
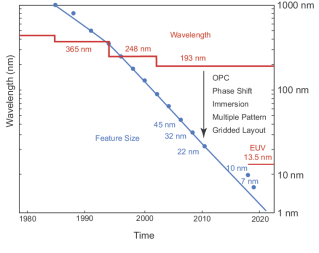 ?
?
圖2?集成電路特征尺寸和光刻技術的歷史進展?
極端紫外光刻
正在開發(fā)EUV光刻技術����,以滿足22納米以下特征尺寸的單次曝光構圖要求(圖3)����。這項技術的獨特之處在于光源的性質��。更多信息請參見極端紫外線光刻���。
 ?
?
圖3?EUV光刻示意圖?
精密DUV光學
在半導體光刻系統(tǒng)中��,光分子污染是可靠性和壽命的重要問題��。因此��,必須非常小心地防止這些系統(tǒng)中的光學器件暴露于粘合劑�����、潤滑劑和任何其他有機碳以及硅氧烷���、膦酸鹽或硫酸鹽�。有機物在DUV范圍內具有吸收性�,在光學器件表面吸附和隨后的DUV照明后,會發(fā)生反應形成各種破壞性污染物���。揮發(fā)性有機化合物��、可冷凝的硅氧烷和無機化合物的微量污染會導致光在透射或反射中損失��,并可能導致波前畸變��,嚴重影響性能并導致計劃外停機�����。它會導致斯特雷爾降低(或光學成像質量降低)�����、偏振變化甚至去調諧�����,即光學波長的偏移�����,從而對光刻系統(tǒng)的性能產生負面影響���。光分子污染的范圍包括DUV波長(190 - 355納米)和EUV波長(低于190納米�����,通常為13.5納米)���。光分子污染機制很復雜���,高度依賴于功率水平以及化合物的類型和濃度。有多個方面需要考慮�����,具體的解決方案必須在具體的應用中得到理解和證明����。隨著波長的不斷縮短和功率的增加,防止這種形式的化學污染變得越來越重要�。
光學制造商擁有消除或限制光分子污染影響的方法����,有助于實現高性能、長壽命的光學器件和系統(tǒng)��。其中包括專有的光學材料和化合物��、專有的拋光�����、清潔和涂層工藝�,以及潔凈室處理設備和工藝����。本節(jié)描述了將DUV光學系統(tǒng)與標準目錄光學系統(tǒng)區(qū)分開來的功能���,包括:
1.?料科學領域的廣泛R&D可靠性和壽命測試
2.?系統(tǒng)的初始設計
3.?長壽命和最小預防性維護周期的系統(tǒng)設計
4.?次級供應鏈管理和控制
5.?內部潔凈室環(huán)境和生產控制
6.?保持清潔和包裝
????????
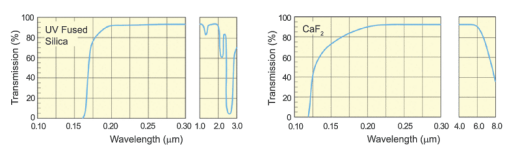
圖4?DUV光學材料透射圖
許多光學材料在200納米以下具有低透射率,因此紫外熔融石英或氟化鈣(CaF2)是DUV透射光學襯底的首選材料���。圖4顯示了這些材料的典型透射率�����,該透射率在200納米以下,然后急劇下降�。然而,如果不使用特別優(yōu)化的工藝進行涂覆����,CaF2光學器件容易出現缺陷和滑移面�。在選擇與DUV波長兼容的拋光化合物和工藝方面進行了廣泛的研究和測試。一些拋光材料/化合物會吸收紫外線/DUV光�����,這會影響光學元件的可靠性和壽命��。其他可能包含直接與DUV光反應導致?lián)p壞和故障的化合物�����。
EUV光刻的真空控制
EUV對光學組件和真空控制的規(guī)格有嚴格的要求。EUV光源需要硬真空���,因為所有氣體都吸收13.5納米的光�����。使用過程控制設備����,如MKS流量控制器�、閥門和壓力表。
壓電式壓力計在一個封裝中包含兩個壓力計:一個微機電系統(tǒng)micro pirani傳感器和一個壓電式傳感器��。它們是為負載鎖設計的���,測量壓力范圍從大氣壓到中等真空(1000到1x10-5托)��。這一寬范圍允許該儀表用于要求絕對真空/壓力切換能力的真空室應用中。
DUV光刻的精確運動控制
DUV光刻需要高速運動平臺來處理具有高精度和穩(wěn)定性以及快速步進和穩(wěn)定時間的晶片��。覆層(一個圖案層相對于另一個圖案層的相對位置)�����、臨界尺寸和生產量推動了掩模版和晶片階段的這些要求�,在193納米技術中,典型的覆層公差為臨界尺寸的15%��。吞吐量要求(高達200個晶片/小時)將每個晶片的最大處理時間限制在20秒以內�。這意味著在掩模版和晶片平移操作中出現相對較高的速度和加速度���。這些光刻工具中的運動控制系統(tǒng)必須能夠在不影響掩模版或晶片振動水平的情況下實現這些速度和加速度�����,因為這會影響可實現的光盤?����?焖俨竭M和建立需要主動隔振���,以最小化光學柱的振蕩和隨后的照明延遲。
除了更高的速度之外�����,通過增加管芯尺寸��,使得每個晶片處理更少的管芯�����,吞吐量也被最大化�。然而,這種方法增加了對定位精度的要求��。光刻應用需要運動平臺校準����,以確保晶圓廠中許多不同平臺定位的可重復性���。
注意:此處包含的信息、建議和意見僅供參考����,僅供您考慮,查詢和驗證����,不以任何方式 保證任何材料在特定下的的適用性。華林科納CSE對以任何形式、任何情況�,任可應用���、測試或交流使用提供的數據不承擔任何法法律表任��,此處包含的所有內容不得解釋為在任何專利下運營或侵如任何專利的 許可或授權�。
?