
掃碼添加微信�����,獲取更多半導體相關資料
摘要
? ? ? 描述了一種從硅和二氧化硅中去除氮化硅層的高選擇性干法刻蝕工藝���,并對其機理進行了研究。與傳統(tǒng)的Si3N4去除工藝相比����,這種新工藝采用遠距離O2 /N2放電,CF4或NF3作為氟源的流量小得多���。對于作為氟源的CF4����,Si3N4的蝕刻速率達到超過30納米/分鐘,同時Si3N4與多晶硅的蝕刻速率比高達40�,并且二氧化硅根本沒有被蝕刻。對于作為氟源的NF3��,實現(xiàn)了50納米/分鐘的Si3N4蝕刻速率���,而對多晶硅和二氧化硅的蝕刻速率比分別約為100和70�。原位橢偏法顯示在多晶硅頂部形成約10納米厚的反應層�。該氧化的反應層抑制了反應性氣相物質與硅的蝕刻反應。
?
介紹
? ? ? 硅局部氧化后氮化硅掩膜材料的剝離~LOCOS�����!是集成電路期間器件損壞的可能來源捏造����。襯墊氧化物在過蝕刻過程中會退化��。此外�,蝕刻劑可以通過墊氧化物中的缺陷到達下面的硅襯底,并且以顯著的速率蝕刻襯底��。這種效應在基底上留下凹坑���,稱為“點蝕”���。目前用于Si3N4剝離步驟的干法工藝有利于這種不希望的效果�����,因為它們蝕刻硅的速度通常比Si3N4快得多.因此�,在二氧化硅和硅上選擇性蝕刻Si3N4的工藝是理想的�。
?
實驗
? ? ? 實驗用藍寶石涂敷器在1000瓦的微波功率和600毫托的室壓下進行。在大多數(shù)實驗中�����,O2和N2的流量分別保持在800和110 sccm����。這些參數(shù)被稱為標準條件。
?
結果和討論
? ? ? Si3N4蝕刻速率是作為添加到O2 /N2等離子體中的CF4的函數(shù)來測量的�����。三氟化氮被用作CF4的替代氟源���。Si3N4的蝕刻速率測量在標準條件下進行����,O2的流量保持恒定在800 sccm。Si3N4的蝕刻速率與NF3的流量成正比��,如果使用NF3代替CF4�����,則蝕刻速率明顯更高添加46 sccm的CF4�。

圖1 .Si3N4的蝕刻速率是CF4流量的函數(shù)?
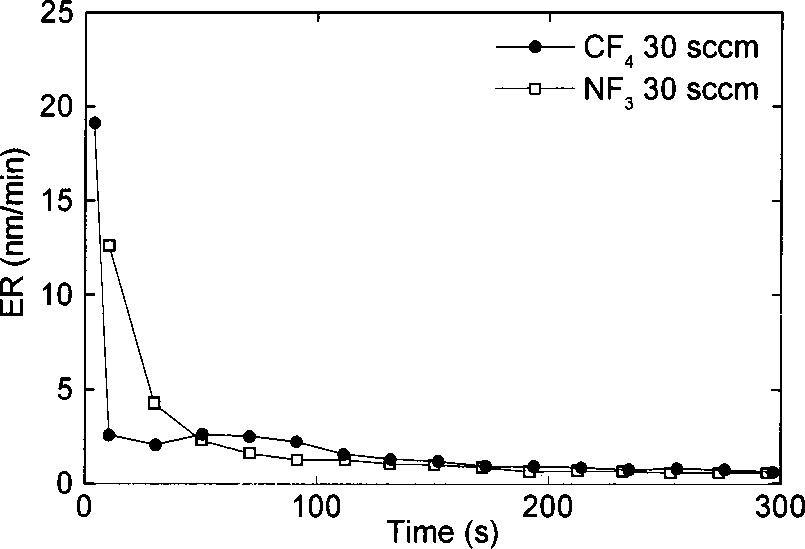 ?
?
圖2.標準條件下作為氟源的CF4和NF3的多晶硅蝕刻速率。在實驗之前�����,樣品被氫氟酸浸泡以去除自然氧化層�。當在蝕刻過程中形成富氧反應層時,最初的高蝕刻速率被抑制
??
結論
? ? ? 一種新穎的遠程等離子體化學干法刻蝕~CDE.已經證明了能夠以大于30∶1的蝕刻速率比在硅和二氧化硅上選擇性蝕刻Si3N4的工藝�����。它使用高流量的O2和N2���,以及相對少量的CF4和NF3作為氟的來源。
? ? ? 對于這里報道的實驗�,氮化硅的蝕刻速率受到表面的氟原子流量的限制���。一氧化氮含量豐富,不會影響Si3N4的蝕刻速率���。這與向CF4或NF3放電中加入少量O2和/或N2的過程相反���。
? ? ? 顯著降低的氟原子密度,特別是對于CF4作為氟源的情況����,不足以以比硅更高的選擇性蝕刻Si3N4。此外���,由室中的高一氧化氮密度提高的Si3N4蝕刻速率不足以獲得高蝕刻速率比����。從上面給出的數(shù)據可以得出結論���,在硅的頂部形成蝕刻抑制反應層是實現(xiàn)高Si3N4蝕刻速率比的主要機制��。原始硅表面的蝕刻以大約20納米/分鐘的速率進行���。原位橢偏儀顯示在蝕刻過程中�����,在幾秒鐘內���,在多晶硅頂部形成反應層。反應層形成后��,硅的蝕刻速率降低到與二氧化硅相當?shù)乃健?/span>
? ? ? 最后�����,作者想建議��,不完美的柵極氧化物可以通過這里研究的工藝來潛在地改善����。蝕刻期間在硅頂部形成的反應層被高度氧化,含有一些氟�,因此類似于柵極氧化物。在去除Si3N4之后的過蝕刻期間�,柵極氧化物中空隙或缺陷下面的硅可能被氧化,因此改善了柵極的電性能���。
?
?
文章全部詳情�,請加華林科納V了解:壹叁叁伍捌零陸肆叁叁叁