
掃碼添加微信��,獲取更多半導體相關資料
本文通過使用循環(huán)極化技術研究了硅在EPW各向異性蝕刻劑(乙二胺、鄰苯二酚和水)溶液中的陽極氧化�����,用x光電子能譜和二次離子質譜對樣品進行了表征��。
用自動擴散電阻(ASR)輻照根據兩個16的火山硼的濃度分布���,結果如圖1所示,在進入17至10陽極氧化測試以產生相同的表面條件之前�,使用氫氟酸溶液去除晶片表面的酸膜���。
?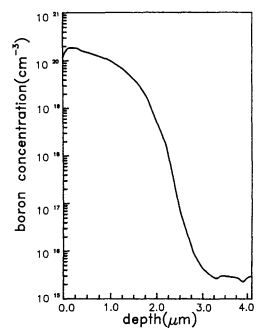
圖1
繪圖儀尺寸和光束電壓分別為3×3mm2和0.7kV�����,參比電極為ag / AgCl電極���,反電極采用AP網絡,并安裝溶液濃度�,以保持電容器持續(xù)處于受控狀態(tài)。此外���,在實驗過程中,通過通入氮氣防止溶液氧化��,陽極氧化和循環(huán)極化的兩個實驗實例斜坡率= 02毫伏/秒�����,初始電位為-100毫伏對����。使用SIMS提高了一個體積的表面中硼的濃度�。圖2用于陽極極化和陰極極化的實驗裝置���。
?
圖2
在耐腐蝕金屬(如不銹鋼)中顆粒的鉻確定陽極氧化的情況下�,由點引起的內腐蝕����,其中當沿相反方向掃描從無源區(qū)域到有源區(qū)域的電位以觀察局部不穩(wěn)定形成的氧化膜破裂時電流密度的行為時,電流子點迅速降低�。該研究實施例通過識別方法觀察硅陽極氧化膜的行為,并在y電位時清洗種子中的樣品���。在本研究中,蝕刻-為提供硅陽極氧化膜的基礎數據���,作為確定停止機理的一部分���,首先引入一種分析技術,根據陽極氧化膜作為鈍化膜的蝕刻低方向性��,即在溶液中如何穩(wěn)定地起伏�,所有電化學腐蝕都是高度活躍的。
此外�����,通過表面分析��,根據添加劑雜質的類型或濃度���,觀察陽極氧化膜和心肌表面的藍色和干凈的方面��,正在使用重摻雜蝕刻停止方法���,p-n結蝕刻停止方法是一種電化學g方法���,其利用si的陽極氧化氧化特性和p-mi結的電特性�����,這極大地增加了在反向偏置p-n結鉗夾下的n型Si實例的PHL型Si的蝕刻停止�����,重摻雜蝕刻停止方法使用眾所周知的實驗結果,即當硼的濃度為5×101”cm3或更高時�,通過使用e-速度的雜質依賴性��,蝕刻速率顯著降低,對于使用p-n結的電化學蝕刻停止���, 電化學動力學數據的基礎是氮硅的鈍化電位比硅的鈍化電位更具陰極性�����,蝕刻通過在陰極區(qū)設置任何一個小孔而不是鈍化電位和磷硅,選擇性地施加任何一個小孔而形成的間硅雙邊氧化膜�����,起著鈍化膜的作用����。
在陽極氧化的情況下,取出樣品�,并在超過電位�����,即電流密度急劇降低的PP(通過電位)的時間進行清洗�,循環(huán)極化頂點電位為100毫伏vs,PP為8�。在本研究中,p-Si的OCP和PP比mSi的情況略高����,因此,有源區(qū)跨越了更寬的勢規(guī)則���。一般來說�����,當半導體被放置在電解質袋中時�,與金屬的準晶不同���,空間電荷層被留在具有電解質的表面中的半導體表面上��。在電極上使用陽極x射線(1486.6eV)在300瓦����、12kV下對其進行測試��。
?
因此�,通過實驗可以推斷,與輕摻雜的情況相比����,這種光下的陽極上膜具有更好的化學狀態(tài)�,即作為鈍化膜的特性�����。此外有源區(qū)形成在非常窄的電勢隊長中�����,最大電流密度與光do-ping的情況相比�,顯示出大約200至300張的小值����。如果電位從化學位移被動區(qū)向下掃描到靜態(tài)區(qū)向下掃描����,可以看出掃描速率沒有顯示出聚丙烯中電流密度的中間值,并且在主動區(qū)中一直保持被動狀態(tài)�����,即使此時它足夠慢以維持系統(tǒng)的平衡狀態(tài)。然而����,在輕摻雜的情況下�����,通過顯示在到達OCP之前預先預測的氧化膜破裂之外的突然干燥的中間值���,示出了遵循非掃描(a)寧時間的曲線�����。在硅單晶的情況下,它在物質上處于非常均勻的狀態(tài)���,并且在向下掃描時由穿孔密度(中間價格)引起的峰值達到潛在例子的電流密度�����,并且它似乎幾乎同時發(fā)生在滑動表面上���,而不是局部地����,因為它位于硅的陽極氧化膜的不銹鋼上的破損處。
通過注入這些陽極氧化物氧化物化學gtate的XIPS分析結果����,在原子極化狀態(tài)下,表面上的硼濃度分布得高得多�,而不管它是否發(fā)生�,氧化膜的電負性甚至在陽極酸膜通過硼向表面的移動而被清潔之前就出現了,原因是這是由于o-nias的潛力���,但需要更多的研究來確定確切的原因�,然而���,作為上述結果,通過拖延可以估計的是����,實際蝕刻頂部凍結時的臨界硼濃度大于裂縫前的報告濃度,這被認為對解釋硼重摻雜蝕刻停止的機理有很大幫助。
循環(huán)極化實驗的結果表明�����,在p型和n型硅片上形成的陽極氧化物在相同的電位下分解���,而在p+-硅的情況下,直到開路電位都沒有發(fā)生分解�。據XPS觀察,磷硅樣品的強抗蝕性與形成強硅氧鍵有關�����。SIMS深度剖面圖表明�,發(fā)生蝕刻停止的硼的臨界濃度似乎比普遍認為的要高得多����。