
掃碼添加微信�����,獲取更多半導(dǎo)體相關(guān)資料
在氫氧化銨溶液中�,使用各向異性硅蝕刻技術(shù),在SOI晶片上制備了無(wú)連結(jié)fet(JL-FET)器件��,以O2/N2電子回旋共振(ECR)等離子體作為柵極介質(zhì)生長(zhǎng)氮氧化硅,以反應(yīng)性濺射作為柵極金屬沉積硝化鈦��,利用掃描電鏡成像和電學(xué)測(cè)量方法對(duì)其結(jié)構(gòu)進(jìn)行了表征��,最終得到的硅通道厚度為65nm����,器件的電性能與預(yù)期一致。
通常在幾納米內(nèi)從1020個(gè)原子/cm3p型摻雜劑到1020個(gè)原子/cm3n型摻雜劑�,相比之下��,JLFET器件在整個(gè)器件中具有相同的摻雜濃度��,從而降低了摻雜劑的擴(kuò)散速率�����,除了使用標(biāo)準(zhǔn)的熱退火和更少的離子注入步驟可以降低制造成本外,JL-FET也因其性能而脫穎而出�,電流密度通過(guò)襯底[1]的厚度分布,參與電流的載流子為大多數(shù)類型,并且一些電荷散射現(xiàn)象可以通過(guò)極化柵在平帶條件來(lái)減輕����,這允許給定器件的更大電流��。
在高頻緩沖溶液中,使用濕式氧化和氧化硅蝕刻法將襯底變薄到約200nm�����,然后將晶片在50keV下離子注入磷�,劑量為1013個(gè)原子/cm2�����,摻雜劑活化在1000°C的常規(guī)烤箱中惰性氣體中進(jìn)行30分鐘,這一離子注入步驟的計(jì)劃比通常劑量低����,因?yàn)檩^低濃度的摻雜雜質(zhì)會(huì)導(dǎo)致更寬的耗盡區(qū)域,通過(guò)犧牲一些電接觸質(zhì)量���,在模擬步驟中只在25nm中觀察到的晶體管行為�,以及在更薄的器件中,即使在75nm厚的器件上也可以觀察到����,通過(guò)光刻技術(shù)確定了活性區(qū)域���。
通過(guò)ECR等離子體培養(yǎng)氧化硅硬掩模,并在HF緩沖溶液中蝕刻�����,然后在氫氧化銨溶液中進(jìn)行各向異性硅蝕刻,持續(xù)40秒����,采用掃描電鏡成像技術(shù)證實(shí)了濕式蝕刻過(guò)程���,柵極氧化物是通過(guò)o2/n2ECR等離子體生長(zhǎng)的氮氧化硅���,柵金屬由光刻和升降機(jī)定義�,由濺射氮化鈦制成,用光刻法和高頻溶液蝕刻法對(duì)覆蓋漏極和源區(qū)的氧化物進(jìn)行蝕刻,用濺射法沉積金屬墊片�����,最終退火分5分鐘進(jìn)行�����,在450°C的常規(guī)烘爐上形成氣體(H2)�。
?
每個(gè)退火步驟后,在Keithley證明上測(cè)量裝置I-V曲線�����,通過(guò)退火和電測(cè)量���,使用Ga+聚焦離子束磨削和掃描電鏡成像提取橫截面圖像�,圖1清楚地顯示了預(yù)期的幾何結(jié)構(gòu),使用圖像編輯所進(jìn)行的測(cè)量�����,軟件結(jié)果表明��,氫氧化銨溶液濕蝕刻后的通道厚度約為65nm���,通道壁在(100)和(111)晶體平面之間的特征角約為57度�,圓形邊緣是在各向異性蝕刻過(guò)程中出現(xiàn)的元穩(wěn)定(311)平面的結(jié)果,這些結(jié)果表明��,在氫氧化銨溶液中使用硅濕蝕刻確實(shí)可以令人滿意地減薄通道厚度。
 ?
?
圖1
每個(gè)退火步驟后進(jìn)行的電測(cè)量取得了不同程度的成功���,顯示最佳接觸質(zhì)量和晶體管行為的測(cè)量是退火20分鐘后的測(cè)量��,與預(yù)期的那樣�����,大多數(shù)測(cè)量結(jié)果顯示柵極電壓對(duì)電流的影響減弱��,如圖所示2�,這是因?yàn)樵?5nm通道厚度時(shí),由柵極引起的耗盡區(qū)域不夠?qū)?�,不足以耗盡每個(gè)載流子,器件的閾值電壓變得非常負(fù)�����,并且器件在大多數(shù)VDS范圍內(nèi)作為門控電阻�。在電觸點(diǎn)質(zhì)量較低,像肖特基二極管��,扭曲了I-V測(cè)量,這是因?yàn)榇蠹s1017個(gè)原子/cm3的最終摻雜濃度在源和漏極區(qū)域不夠高�����,無(wú)法保持歐姆接觸�����。
?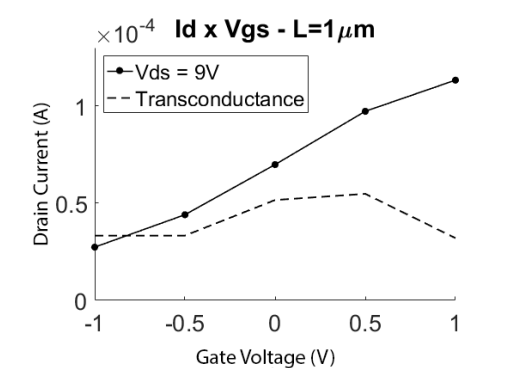
圖2
盡管由于其負(fù)閾值電壓而不能作為開關(guān),但IDxVDS結(jié)果表明發(fā)生了晶體管行為和低柵極漏電流����,所制備的器件具有明確的三極管和飽和區(qū)域的晶體管行為�����,但不能實(shí)現(xiàn)截止�����。對(duì)氫氧化銨濕式蝕刻過(guò)程的進(jìn)一步調(diào)整可能導(dǎo)致JL-FET設(shè)備的電氣性能可與最先進(jìn)的增強(qiáng)型MOSFET設(shè)備相媲美,因此�,本研究證明了氫氧化銨溶液中的各向異性硅刻蝕是一種制薄硅基JL-FET器件通道襯底的可行技術(shù)����。