
掃碼添加微信��,獲取更多半導體相關資料
本研究設計并制造了一種利用橡膠O型圈物理阻止表面蝕刻劑流入的裝置(所述裝置包括加熱器和溫度控制器),通過蝕刻保持恒定的溫度���,也為薄膜結構考慮了蝕刻劑的靜水壓力,利用所制備的器件���,在六英寸的硅晶片上成功地制造了具有800米的輻射度��、600納米的厚度和具有兩個波紋的3 m波紋深度的圓形波紋膜片。
 ?
?
圖1
利用該裝置制備了一種波紋膜,波紋薄膜結構如圖所示1�����,不僅降低了膜的機械剛度�,也廣泛應用于MEMS麥克風中����。在單側濕式蝕刻裝置的結構中��,采用聚四氟乙烯設計,這是一種對氫氧化鉀具有化學抵抗力的材料��,O形環(huán)用于密封晶圓片的前后兩側,并且螺釘和螺紋對O形圈施加足夠的壓力�����,以確保適當?shù)拿芊狻?/span>
在濕式蝕刻中,蝕刻速率取決于氫氧化鉀的濃度和溫度,主要需要濃度為20~30wt%��,溫度為80~90°C,在蝕刻過程中���,使用棒狀筒式加熱器和恒溫器來加熱溶液并保持恒定的溫度,筒式加熱器不直接接觸氫氧化鉀溶液��,通過不銹鋼制的結構來傳遞熱量,并且在頂部使用了一個帶有蓋子的結構,該蓋子有一個洞�,被設計為允許在蝕刻過程中產(chǎn)生的氫氣逃逸�����,因此,即使在很長時間的蝕刻時間后���,溶液的水平也能保持不變����。
在裝置的下部形成一個空腔����,并在刻蝕過程中充滿去離子(DI)水���。因此,可以進入正在進行蝕刻的晶片的另一側與水接觸�����。封閉腔內(nèi)的水在達到準靜力平衡后就像彈簧的作用。這個彈簧自動平衡在晶圓上創(chuàng)建的微觀結構上的壓力����,包括靜水壓力�。壓力平衡將在下一節(jié)中詳細討論。連接到空腔的通風孔位于比晶圓表面更高的位置����;因此�,在加熱期間增加的水量可以逸出��。
如果使用30wt%氫氧化鉀溶液在80~90°C下蝕刻500μm硅,該過程大約需要5小時才能完成�����,因此器件的所有部分在薄膜形成之前都處于熱平衡狀態(tài)�����,當達到熱平衡時,腔內(nèi)捕獲的去離子水的體積因熱膨脹而增加����,并從孔中排出�����。未蝕刻的晶片具有較高的機械剛度,因此在蝕刻開始時無需考慮靜水壓力氫氧化鉀����,當裝置和基底達到熱平衡時�����,關閉排氣孔���,無論氫氧化鉀的高度����、濃度和溫度如何�����,壓力總是平衡的。因此�,即使形成了高彈性結構(如厚度小于1微米的波紋薄膜)�����,該過程也可以安全地進行�����。
最后�����,使用本研究提出的設備中��,在不損傷晶片正面的情況下進行了氫氧化鉀濕式蝕刻�,氫氧化鉀濃度為25-30wt%�,在80°C~90°C下約5h后完成膜的制備���。圖4是制作的波紋膜����,基于光學顯微鏡圖像��,成功地制備了波紋膜。此外�,整個晶片上沒有破壞膜����,大部分膜是按照設計制造的��。
?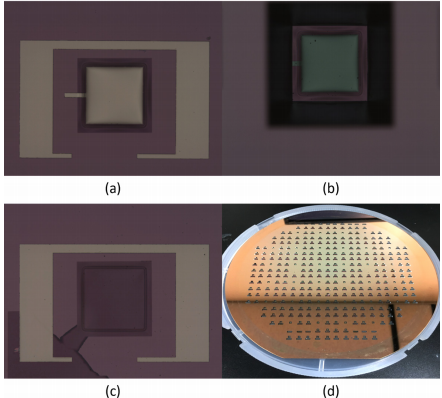
圖4
在濕蝕刻中,整個正表面形成保護膜����,以檢查氫氧化鉀溶液是否穿透基底的前表面,而在陽性PR的情況下���,由于它對氫氧化鉀溶液高度反應,當它與氫氧化鉀接觸時�,PR從底物中移除����,然而當使用所提出的裝置時�����,即使在蝕刻完成后���,正面的PR仍然完全保持��,這證明了氫氧化鉀溶液沒有穿透�����。
作為氫氧化鉀濕式蝕刻的掩膜材料�,使用了500納米的氮化硅薄膜���,在蝕刻過程中保持良好�����,在經(jīng)過長時間的濕蝕刻過程中�,也在視覺上確認了顏色之間的差異����,預計會進行良好程度的蝕刻�。此外如圖所示4(c),濕蝕刻后有一塊膜沒有被破壞�����,且它的形狀不佳�,這是因為相鄰圖案之間的氮化硅層的寬度設計約為100微米,當長時間進行濕蝕刻時�����,圖案之間的氮化硅層不能承受和坍塌�����,可以假定在模式之間保持超過200微米的距離會產(chǎn)生穩(wěn)定的結果�����。
由于在蝕刻過程中可以進行現(xiàn)場監(jiān)測�,因此可以確定終點,當使用氫氧化鉀時�,會產(chǎn)生氫氣,因此當進行蝕刻時����,形成許多氣泡,溶液出現(xiàn)混濁�����,當蝕刻完成后�����,溶液就會變得透明,因為不會產(chǎn)生氫氣��,這也標志著這個過程的結束。最后通過濕式蝕刻裝置�,建議的裝置基于聚四氟乙烯的O形密封裝置和溫度維護金屬結構組成,并且還包括一個用于現(xiàn)場監(jiān)測的蓋子結構和一個壓力排氣孔�。與現(xiàn)有的設備不同����,它可以調整溫度,此外也使晶片中精細的MEMS結構不受蝕刻劑的靜水壓力的影響�。