
掃碼添加微信��,獲取更多把半導(dǎo)體相關(guān)資料
引言
本次在補(bǔ)救InGaP/GaAs NPN HBT的噴霧濕法化學(xué)腐蝕過(guò)程中光刻膠粘附失效的幾個(gè)實(shí)驗(yàn)的結(jié)果�。確定了可能影響粘附力的幾個(gè)因素����,并使用實(shí)驗(yàn)設(shè)計(jì)(DOE)方法來(lái)研究所選因素的影響和相互作用���。確定的最顯著的粘附性改進(jìn)是在光致抗蝕劑涂覆之前立即結(jié)合了天然氧化物蝕刻。除了改善粘附性����,這種預(yù)涂處理還改變了GaAs,使得與未經(jīng)表面處理的晶片相比��,反應(yīng)限制蝕刻更加各向同性;輪廓在都具有正錐度方向���,但錐角不相同���。改變后的剖面使我們能夠使用5200的蒸發(fā)金屬�����,不經(jīng)平面化��,生產(chǎn)出具有5×5 m發(fā)射極的完全可探測(cè)的HBT����。
?
介紹
光致抗蝕劑粘附在濕法蝕刻的結(jié)果以及隨后的電氣和光學(xué)器件的產(chǎn)量中起著關(guān)鍵作用����。有許多因素會(huì)導(dǎo)致光致抗蝕劑粘附到半導(dǎo)體襯底上����。然而�,公開(kāi)文獻(xiàn)中關(guān)于砷化鎵的信息非常少,硅常用的方法��,如六甲基二硅氮烷(HMDS)預(yù)處理可能對(duì)GaAs無(wú)效�����。
我們的歷史蝕刻工藝進(jìn)行了兩個(gè)主要的工藝改變,首先�����,我們從Clariant AZ4330光刻膠切換到Shipley SPR220-3�。我們已經(jīng)發(fā)現(xiàn)����,后一種抗蝕劑具有更好的旋轉(zhuǎn)均勻性和分辨率,但是其對(duì)GaAs的粘附力略次于AZ4330��。其次,我們將濕蝕刻從基于手動(dòng)浸沒(méi)的工藝轉(zhuǎn)移到SSEC 3300噴霧蝕刻系統(tǒng)��。雖然有可能產(chǎn)生更好的蝕刻均勻性和可重復(fù)性���,但是噴霧蝕刻系統(tǒng)可能是對(duì)光致抗蝕劑粘附力的苛刻測(cè)試,并且在錯(cuò)誤的情況下可能導(dǎo)致工藝失敗��,如圖1所示��,圖1示出了遇到噴霧蝕刻系統(tǒng)的第一批中的一個(gè)典型器件。
?
濕法蝕刻工藝
最初的光刻過(guò)程作為后面描述的研究的控制�����。平版印刷術(shù)由140℃的HMDS蒸氣底漆�����、用于2.2 m膜的5 kRPM涂層和115℃的90秒軟烘烤組成,在Microtec ACS200涂層/顯影軌道上進(jìn)行�。然后用ASML PAS5000/55 i線投影步進(jìn)機(jī)對(duì)樣品進(jìn)行曝光(劑量=370mJ/cm2),在115℃下曝光后烘烤90秒�����,和Co. NMD-W (2.38 % TMAH)顯影劑中旋轉(zhuǎn)顯影1分鐘�����。然后將它們?cè)?20℃下進(jìn)行后顯影烘烤兩分鐘,并在Tepla 300桶灰化器中進(jìn)行氧等離子除渣一分鐘���。熔渣是200瓦、750毫托的等離子體�����,氮?dú)夂脱鯕獾牧魉俜謩e為500 sccm和10 sccm��。通常�����,在去渣過(guò)程中�����,樣品水平放置在金屬板上。
然后用20 H2O∶1 NH4OH清洗樣品10秒鐘(蝕刻前清洗),并在1 h3po 4∶4 H2O 2∶45 H2O溶液中蝕刻����。在光致抗蝕劑剝離后���,通過(guò)用光學(xué)顯微鏡目視檢查來(lái)確定粘合質(zhì)量。對(duì)研究中的每個(gè)晶片進(jìn)行主觀粘合評(píng)級(jí)����,10為最好�,0為最差����。蛇形結(jié)構(gòu)對(duì)判斷粘接質(zhì)量特別有幫助���,因?yàn)樗鼈冊(cè)谙鄬?duì)較小的觀察區(qū)域內(nèi)提供了粘接失效的充分機(jī)會(huì)�。圖2顯示了這種蛇形結(jié)構(gòu)的一個(gè)例子���,說(shuō)明了一種解決的故障模式�����。
?
圖2 在沒(méi)有預(yù)涂處理的情況下���,在基極-集電極蝕刻之后觀察到的蛇形結(jié)構(gòu)
?
初始分割
為了研究抗蝕劑粘附問(wèn)題,在抗蝕劑粘附DOE之前��,使用n型(100) GaAs機(jī)械的手動(dòng)��、基于浸沒(méi)的蝕刻(蝕刻深度約為2 m)進(jìn)行工藝分離。分裂顯示,與對(duì)照相比����,增加的脫水烘烤(120℃10分鐘)和更高的顯影后烘烤(130℃2分鐘)對(duì)改善粘附性幾乎沒(méi)有作用。在光致抗蝕劑涂覆之前�����,更具侵蝕性的���、五分鐘�����、600 W�、225毫托、O2流速為600 sccm的除渣導(dǎo)致粘附質(zhì)量下降����。讓樣品靜置三天而不是立即蝕刻,降低了除20 H2O∶1 NH4OH預(yù)涂處理樣品之外的所有樣品的粘合性���。20 H2O∶1 NH4OH的預(yù)涂處理10秒鐘產(chǎn)生優(yōu)異的粘附性。此外��,10秒鐘的10 H2O∶1 HCl預(yù)蝕刻清洗比基于氫氧化銨的清洗改善了粘附性�����。
這些初始分裂的令人驚訝的結(jié)果是(100) N型GaAs晶片的輪廓,當(dāng)如圖3所示施加20 H2O∶1 NH4OH預(yù)涂覆處理時(shí)��,該輪廓在兩個(gè)結(jié)晶方向上都是錐形的����。當(dāng)觀察通常為逆行的橫截面時(shí)�����,預(yù)涂處理的剖面的斜率約為50 °,當(dāng)觀察通常為錐形的橫截面時(shí)�����,斜率約為40°�����。
?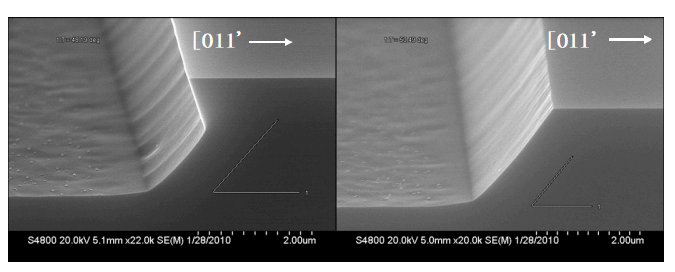
圖3 GaAs的濕法蝕刻輪廓�����,沒(méi)有預(yù)涂覆天然氧化物蝕刻(左)和在涂覆前立即進(jìn)行天然氧化物蝕刻(右)
?
抗粘連劑
為了進(jìn)一步表征和優(yōu)化蝕刻工藝,進(jìn)行了抗蝕劑粘附DOE�。蝕刻深度為約0.8 μm,并且在光刻后的第二天在噴霧蝕刻工具中蝕刻樣品��。
一個(gè)重要的工藝細(xì)節(jié)是樣品的氧等離子體殘?jiān)?�,其垂直放置在石英舟上����,而不是水平放置在金屬網(wǎng)格上�。在將對(duì)照樣品與其他實(shí)驗(yàn)進(jìn)行比較時(shí)�����,石英舟的使用可能在某些條件下顯著降低粘附力,因?yàn)樗咕瑹岣綦x����,允許它們?cè)谌ピ^(guò)程中變熱��。這導(dǎo)致抗蝕劑粘附的不良表面��。第二個(gè)細(xì)節(jié)是在噴霧蝕刻工具中進(jìn)行的基于NH4OH的預(yù)蝕刻清潔,而基于HCl的預(yù)蝕刻清潔是通過(guò)浸泡在酸工作臺(tái)上手動(dòng)進(jìn)行的�。當(dāng)在沒(méi)有任何預(yù)涂處理的情況下進(jìn)行基于NH4OH的預(yù)蝕刻清洗時(shí),增加的噴射壓力可能導(dǎo)致觀察到的差的粘附力�����。
這些初始分裂的令人驚訝的結(jié)果是(100) N型GaAs晶片的輪廓��,當(dāng)如圖3所示施加20 H2O∶1 NH4OH預(yù)涂覆處理時(shí)�,該輪廓在兩個(gè)結(jié)晶方向上都是錐形的。當(dāng)觀察通常為逆行的橫截面時(shí)����,預(yù)涂處理的剖面的斜率約為50 °,當(dāng)觀察通常為錐形的橫截面時(shí)���,斜率約為40°���。
結(jié)論
我們已經(jīng)確定了在濕法蝕刻過(guò)程中影響光致抗蝕劑對(duì)GaAs粘附的許多因素���?��?刮g劑粘附的結(jié)果確實(shí)表明,即使在不利的粘附條件下�����,也可以通過(guò)在光刻之前實(shí)施自然氧化物蝕刻來(lái)獲得優(yōu)異的粘附。這種相同的預(yù)涂處理也改變了(100) GaAs的蝕刻輪廓�,表明蝕刻輪廓對(duì)GaAs表面的依賴性。作為這項(xiàng)工作的結(jié)果�����,所實(shí)施的改變極大地增加了視覺(jué)和功能產(chǎn)量���,而沒(méi)有顯著改變電氣性能��。