
掃碼添加微信,獲取更多半導體相關資料
引言
本文主要闡述在補救InGaP/GaAs NPN HBT的噴霧濕法化學腐蝕過程中光刻膠粘附失效的幾個實驗的結(jié)果��。確定了可能影響粘附力的幾個因素���,并使用實驗設計(DOE)方法來研究所選因素的影響和相互作用。確定的最顯著的粘附性改進是在光致抗蝕劑涂覆之前立即結(jié)合了天然氧化物蝕刻�。除了改善粘附性�,這種預涂處理還改變了���,使得與未經(jīng)表面處理的晶片相比��,反應限制蝕刻更加各向同性;輪廓中都具有正錐度方向�,但錐角不相同�����。改變后的剖面使我們能夠使用5200的蒸發(fā)金屬����,不經(jīng)平面化����,生產(chǎn)出具有5×5 m發(fā)射極的完全可探測的HBT。
?
介紹
光致抗蝕劑粘附在濕法蝕刻的結(jié)果以及隨后的電氣和光學器件的產(chǎn)量中起著關鍵作用����。有許多因素會導致光致抗蝕劑粘附到半導體襯底上����。然而����,公開文獻中關于砷化鎵的信息非常少,硅常用的方法�,如六甲基二硅氮烷(HMDS)預處理可能對GaAs無效���。
此外,GaAs的表面很難控制�����,可能對看似微小的工藝條件很敏感�,例如用水沖洗晶片的時間長度����。
據(jù)我們所知����,只有一篇參考文獻引用了在GaAs上使用預涂自然氧化物蝕刻來提高粘附性。該參考研究表明�����,基于水滴接觸角實驗�����,預涂處理是有前途的,并且在光致抗蝕劑顯影步驟之后驗證了粘附性����。沒有參考文獻引用在濕法蝕刻過程中使用預涂處理進行粘合也不影響對濕法蝕刻輪廓的觀察效果��,這通常歸因于蝕刻劑的GaAs晶體結(jié)構(gòu)和性質(zhì)。
?
實驗過程
對我們的歷史蝕刻工藝進行了兩個主要的工藝改變���,使得這項工作成為必要。首先�,我們從Clariant AZ4330光刻膠切換到Shipley SPR220-3�����。我們已經(jīng)發(fā)現(xiàn)���,然后一種抗蝕劑具有更好的旋轉(zhuǎn)均勻性和分辨率,但是其對GaAs的粘附力略次于AZ4330�。其次����,我們將濕蝕刻從基于手動浸沒的工藝轉(zhuǎn)移到SSEC 3300噴霧蝕刻系統(tǒng)�����。雖然有可能產(chǎn)生更好的蝕刻均勻性和可重復性���,但是噴霧蝕刻系統(tǒng)可能是對光致抗蝕劑粘附力的苛刻測試�,并且在錯誤的情況下可能導致工藝失敗�,如圖1所示�����,圖1示出了遇到噴霧蝕刻系統(tǒng)的第一批中的一個典型器件����。
為了進一步表征和優(yōu)化蝕刻工藝��,進行了抗蝕劑粘附DOE�。蝕刻深度為約0.8 μm��,并且在光刻后的第二天在噴霧蝕刻工具中蝕刻樣品���。
一個重要的工藝細節(jié)是樣品的氧等離子體殘渣,其垂直放置在石英舟上��,而不是水平放置在金屬網(wǎng)格上��。在將對照樣品與其他實驗進行比較時�,石英舟的使用可能在某些條件下顯著降低粘附力��,因為它使晶片熱隔離�����,允許它們在去渣過程中變熱�。這導致抗蝕劑粘附的不良表面�����。第二個細節(jié)是在噴霧蝕刻工具中進行的基于NH4OH的預蝕刻清潔���,而基于HCl的預蝕刻清潔是通過浸泡在酸工作臺上手動進行的。當在沒有任何預涂處理的情況下進行基于NH4OH的預蝕刻清洗時�,增加的噴射壓力可能導致觀察到的差的粘附力��。
如圖4所示,結(jié)合了來自DOE的預涂處理的樣品的蝕刻輪廓在臺面的頂部具有輕微的唇緣�。該唇緣可以解釋為使用噴涂工具的部分粘附損失�����,或者當前的噴涂蝕刻工藝不能去除光致抗蝕劑/GaAs界面處的材料�����。我們正在研究方法消除觀察到的唇部��。
?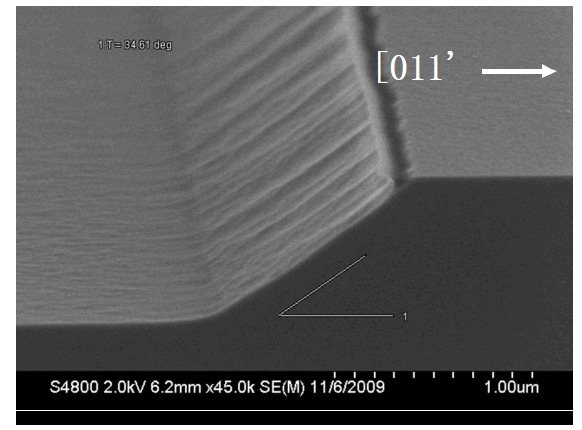
圖4 來自DOE的基于NH4OH的預涂層處理和基于NH4OH的預蝕刻清洗的HBT設備批次
起初�����,我們對在最終的HBT蝕刻流程中采用預涂處理猶豫不決�����,因為目視觀察顯示��,它們略微減小了蝕刻臺面頂部的尺寸�,如圖7所示��。然而���,如表II所示�,在前面討論的兩個晶片中沒有觀察到電特性的重大變化。預涂處理樣品的增益更大�,但分布更廣,這可能需要進一步研究����。Icbo和Iebo�,兩種工藝的基極-集電極和發(fā)射極-基極結(jié)的漏電流是相當?shù)摹?/span>
?
結(jié)論
我們已經(jīng)確定了在濕法蝕刻過程中影響光致抗蝕劑對GaAs粘附的許多因素?����?刮g劑粘附的結(jié)果確實表明,即使在不利的粘附條件下�����,也可以通過在光刻之前實施自然氧化物蝕刻來獲得優(yōu)異的粘附�����。這種相同的預涂處理也改變了(GaAs的蝕刻輪廓�,表明蝕刻輪廓對GaAs表面的依賴性。作為這項工作的結(jié)果����,所實施的改變極大地增加了視覺和功能產(chǎn)量,而沒有顯著改變電氣性能�。